Идентификация параметров математических моделей биполярных транзисторов КТ209Л, КТ342Б и полевого транзистора КП305Е
Московский государственный технический университет
им Н.Э. Баумана
Калужский филиал
Пояснительная записка к курсовой работе
по курсу «Физика полупроводниковых приборов»
на тему:
«Идентификация параметров математических моделей биполярных транзисторов КТ209Л, КТ342Б и полевого транзистора КП305Е»
Содержание
Полевые транзисторы
1. Теоретические сведения по МДП транзисторам
2. Качественный анализ работы МДП- транзисторов
3. Уравнения для описания ВАХ МДП-транзистора
4. Эффект подложки
5. Структурно-физическая эквивалентная схема МOП транзистора
6. Характеристики МДП транзистора
7. Расчетная часть
7.1 Справочные данные
7.2 Описание макета
7.3 Семейство выходных характеристик
Биполярные транзисторы
8. Теоретические сведения по биполярным транзисторам
9. Характеристики транзисторов, используемые для экстракции параметров математических моделей.
10. Расчетная часть
11. Биполярный транзистор КТ209Л
11.1 Справочные данные
11.2 Режимы работы, характеристики
11.3 Расчет коэффициентов неидеальности эмиттерного и коллекторного переходов
12. Биполярный транзистор КТ342Б
12.1 Справочные данные:
12.2 Режимы работы, характеристики
12.3 Расчет коэффициентов неидеальности эмиттерного и коллекторного переходов
13. Малосигнальные параметры биполярных транзисторов
14. Литература
Цель курсовой работы
В ходе выполнения курсовой работы получить знания в области своей будущей профессии, проводя небольшие исследования.
В данной курсовой работе необходимо определить параметры структурно-физических математических моделей диодов и полевых транзисторов, малосигнальных и структурно-физических моделей биполярных транзисторов n-p-n и p-n-p типов. Параметры этих моделей находятся посредством обработки экспериментальных характеристик, которые определяются с помощью двух стендов. На одном из них производится снятие малосигнальных h- параметров биполярных транзисторов при включениях по двум схемам (с общей базой и с общим эмиттером) с использованием прибора Л2-21/1. На другом - производится снятие статических характеристик - входных, выходных, передаточных прямых и обратных в активном режиме и в режиме насыщения. Эти параметры являются главными элементами системы моделирования и анализа радиоэлектронных цепей. Такое моделирование позволяет значительно сократить сроки создания новых изделий РЭА и резко снизить затраты на макетирование этих изделий.
диод транзистор радиоэлектронная цепь
Полевые транзисторы
1. Теоретические сведения по МДП транзисторам
Одними из главных элементов современных ЭВМ являются транзисторы, в основу работы которых положен эффект поля. Такие транзисторы получили название полевых (ПТ) или униполярных, работа которых базируется на модуляции проводимости толщины проводящего приповерхностного слоя полупроводника изменением напряженности поперечного электрического поля. Использование таких транзисторов позволило резко снизить энергопотребление цифровых ИМС и упростить управление мощными энергопотребителями (с тепловыделением до нескольких киловатт). В полевых транзисторах с встроенным каналом (ПТВК) проводимость канала обусловлена движением основных носителей заряда, в полевых транзисторах с индуцированным каналом (ПТИК) проводимость канала обусловлена движением неосновных носителей заряда. В данной работе рассматривается топология, структура, конструкция и функционирование полевых транзисторов с изолированным затвором и индуцированным каналом. Сечение структуры ПТИК с каналом p-типа представлена на рис. 1а, топология представлена на рис. 1б. Электрод подложки может быть формирован с тыльной или с лицевой (планарной) стороны структуры. Далее рассматриваются свойства ПТИК с каналом р-типа. В зависимости от величины напряженности поперечного электрического поля (поля под затвором) ПТ различают режимы обогащения, обеднения и инверсии. В ПТИК в активном режиме имеет место инверсия типа проводимости.
В отсутствие напряжения, приложенного к затвору, р-n -переходы, образованные сильнолегированными областями р+ c подложкой, смещены в обратном направлении. В подложке на границе раздела между полупроводником и диэлектриком образуется положительный заряд подвижных дырок, который уравновешивает отрицательный заряд, образованный в случае подачи на электрод затвора положительного потенциала относительно истока ( и часто соединенной с ним подложки). Если заряд, сообщенный металлизации затвора превосходит тот, что необходим для компенсации встроенного положительного заряда поверхностных состояний и заряда, связанного в диэлектрике, то к приповерхностной области полупроводника подходят из глубины полупроводника неосновные носители заряда - дырки и формируется (индуцируется) проводящая область – канал.
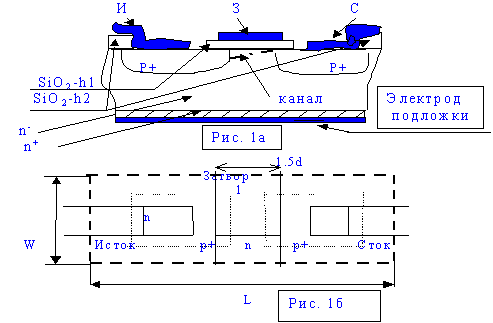
Проводимость канала растет с увеличением потенциала затвора (по модулю). Обозначение полевых транзисторов со встроенным каналом представлено на рис. 2а, а обозначение полевых транзисторов с индуцированным каналом дается на рис. 2б.


Канал отделен от основного объема подложки высокоомным слоем объемного заряда. Поэтому, если на подложке формируются несколько ПТИК, то их взаимным влиянием можно пренебречь (при расстоянии между транзисторами большем, чем толщина высокоомного слоя объемного заряда). Большая толщина диэлектрика под токопроводящими дорожками вне электродных областей истока, стока и затвора гарантирует отсутствие проводящих каналов (т.к. при этом повышается пороговое напряжение под этими проводящими дорожками).
2. Качественный анализ работы МДП- транзисторов
Определим потенциал на поверхности полупроводника, при котором плотность заряда свободных дырок полупроводника превышает плотность заряда свободных электронов и ионизированных атомов примеси. Концентрации электронов и дырок в полупроводнике в присутствии потенциала j на границе между диэлектриком и полупроводником описываются уравнениями:
p = pi exp((-F+qj)/kT)=p0 exp(qj/kT),
n = ni exp((-F-qj)/kT) = n0 exp(qj/kT).
Т.е. равновесные концентрации электронов и дырок связаны с собственной концентрацией, уровнем Ферми и поверхностным потенциалом. Проводящий канал образуется при:
p0exp(qj/kT) > n0 exp(-qj/kT) + Nd,
где Nd = ni (exp(F/kT) - exp (-qj/kT)) -плотность ионизированных атомов донорной примеси, откуда условие образования канала принимает вид:
qj > 2F.
значит заметная проводимость между стоком и истоком появляется при напряжении на затворе, превышающем сумму контактной разности потенциалов на МДП структуре jмдп, напряжения, соответствующего эффективному заряду поверхностных состояний, и напряжения на границе между диэлектриком и полупроводником, когда плотность подвижных дырок превышает плотность электронов и ионизированных атомов донорной примеси. Напряжение, эквивалентное эффективному заряду поверхностных состояний Qss, равно Uпс/Cd, где Сd - удельная емкость слоя диэлектрика, покрывающего канал. Удельную емкость диэлектрика можно определить, зная диэлектрическую проницаемость диэлектрика и его толщину d:
Сd = eeO/d.
Образующийся канал экранирует остальную часть подложки. Дальнейшее изменение напряжения на затворе приводит к увеличению напряжения на слое диэлектрика, а напряжение на слое объемного заряда в подложке остается практически неизменным. Падение напряжения на слое ОПЗ можно изменить прикладывая напряжение к электроду подложки относительно истока. Положительное напряжение, приложенное к подложке, увеличивает проводимость канала. Uпор - такое напряжение на затворе, при котором канал появляется. Граничное напряжение Uси.гр. делит ВАХ ПТ на две области - крутую и пологую зависимости тока стока от напряжения сток-исток.
3. Уравнения для описания ВАХ МДП-транзистора
В стационарном состоянии полный заряд в МДП-структуре, приходящийся на единицу площади, должен равняться нулю. Значит,
Q = Qp + Qn + Qss + Qопз + Qмдп,
где Q- заряд, равный заряду, появившемуся на обкладке затвора, Qp -заряд подвижных дырок, Qn- заряд подвижных электронов, Qss - заряд поверхностных состояний, Qопз - заряд обедненного слоя, Qмдп - заряд электронов в подложке, обусловленный разностью работ выхода в мдп структуре (работы выхода металла и работы выхода полупроводника).
Ток в канале ПТИК (ток стока) в наиболее общем случае определяется, согласно формуле:
Id = (ze0edmp/Ld) { (Ugs - Uмдп - Qss/Cd -jко)Uds – Uds2/2- - 2/3 (d/ eo ed) (2eoeqNd)1/2((Uds + Ubs +jко)3/2 - (Ubs + jко)3/2)}.
Здесь z - ширина канала, mр. - подвижность носителей заряда в канале, d - толщина подзатворного диэлектрика, а L - длина канала, ed – относительная диэлектрическая проницаемость подзатворного диэлектрика.
В рамках упрощенной модели в пологой области ВАХ МДП -транзистора следуют формулам:
![]()
при напряжении на затворе меньшем, чем напряжение отсечки (для транзистора с встроенным каналом) или при пороговом напряжении (для транзистора с индуцированным каналом). Реальные выходные характеристики МДП- транзисторов показывают резкую (крутую) и слабую зависимости тока стока от напряжения сток-исток (см. рис. 3).
На крутом участке выходной характеристики (в ненасыщенном состоянии) ток стока приближенно может быть описан как :

где параметр BETA для р- канального транзистора находится в соответствии с формулой:
![]() .
.
Выход на слабую зависимость тока стока от величины приложенного напряжения сток-исток происходит в связи с тем, что образуется горловина (область вблизи стока, лишённая носителей заряда). При дальнейшем увеличении стокового напряжения имеет место уменьшение эффективной длины канала и возможно смыкание областей истока и стока. Причины данного поведения кроются в модуляции длины канала под действием UDS и генерации- рекомбинации носителей заряда в обедненной области стока.
В режиме насыщения ток стока изменяется в соответствии с формулой:


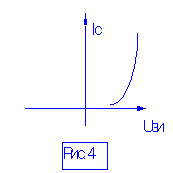
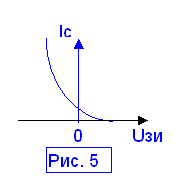
Основные особенности структуры в области насыщения:
q обедненный слой простирается в область канала, и толщина этого слоя зависит от напряжения Uси;
q падение напряжения на участке канала, начинающемся от истока, в первом приближении не зависит от потенциала стока.
В пологой области ВАХ напряжение на канале имеет тенденцию оставаться постоянным и равным UGS – UTO. Поэтому разность между потенциалом стока и падением напряжения на канале оказывается приложенным к ОПЗ у поверхности полупроводника (длина этого слоя L’). И падение напряжения на этом слое равно UDS- (UGS – UTO). При росте UDS величина L’ возрастает, т.е. модуляция напряжения UDS приводит к модуляции эффективной длины канала L = Lт - L’, где Lт - полная длина канала от истока до стока. Увеличение напряжения на стоке уменьшает длину канала и, значит, его сопротивление. Для сохранения постоянного напряжения на канале (UDS – UTO) ток стока должен возрасти так, чтобы компенсировать уменьшение сопротивления канала. Этот рост тока стока с ростом выходного напряжения выявляет положительную обратную связь, которая обусловливает конечное выходное сопротивление птик. Чаще модуляцию длины канала учитывают модификацией уравнения для тока стока в насыщении:
Ic = (b/2)(UGS – UТО)2(1+lUDS).
Типовые значения параметра модуляции l =(0.01-0.1) 1/В. Т.е. для полевых транзисторов этот эффект есть аналог эффекта Эрли с точки зрения влияния питающего напряжения на выходные характеристики МДП- транзисторов. При соединении истока и подложки накоротко они находятся под одним потенциалом, а значит ток генерации Ig уравновешивает ток рекомбинации Ir в р-n переходе” исток - подложка”. Сток и подложка образуют обратносмещенный р- n переход, в котором Ig >>Ir. Этот ток складывается с током стока Ic и дает дополнительный вклад в наклон ВАХ МДП транзистора в области насыщения.
4. Эффект подложки
Под этим явлением понимают изменение характеристик транзистора при подаче напряжения на исток-подложку. С ростом напряжения на подложке (нижнем затворе) относительно истока (UBG) область обедненного слоя расширяется вглубь подложки. Т.к. Qp = Qss + Qос + Qр, то рост Qос приводит к увеличению UTO, а значит и к уменьшению ID. С учетом обратного смещения подложки относительно истока для порогового напряжения получается соотношение:
UTO = - K(2UF + UBG)1/2 + Uпс.
Здесь К = ±(2qee0N/Cd)1/2
Uпс = Qss/ Cd,
UF = kT /qln(N/ni) - потенциал Ферми (N = Nd - для прибора с каналом р-типа и Na -для прибора с каналом n-типа. Зависимость Uпор от величины (UF - Uпз)1/2 представляет собой линейную функцию. Из тангенса угла наклона этой прямой можно найти концентрацию примеси в подложке. Точка пересечения графика с осью ординат соответствует Uпс - части порогового напряжения, обусловленной зарядом Qss. Вычислив Uпс можно найти концентрацию поверхностных состояний Nss. Uпс = - Qss/Cd = qUпсN/(ede0 )
 |
В динамике надо ещё учитывать ёмкости затвор- исток и затвор - сток. Скалярный коэффициент А используется для моделирования параллельного включения нескольких транзисторов.
Структурно-физическая эквивалентная схема МOП транзистора
6. Характеристики МДП транзистора
Параметры прибора зависят от структуры канала - встроенный или индуцированный и от типа проводимости канала. Для ПТ со встроенным каналом напряжение на затворе относительно истока может быть обоих знаков, а для ПТ с индуцированным каналом - только одного знака. Выходные характеристики транзисторов с индуцированным и встроенным каналом представлены на рис. 3. Очень существенны передаточные характеристики - зависимости тока стока от напряжения затвор-исток (рис. 3,4). На рис. 4 приведена передаточная характеристика полевого транзистора с индуцированным каналом n-типа (ПТИК) и на рис. 5 передаточная характеристика полевого транзистора со встроенным каналом p-типа (ПТ ВК).
Если к стоку приложено небольшое напряжение, то ток от истока к стоку течет через проводящий канал, который действует как сопротивление, и ток стока пропорционален напряжению сток-исток. Это линейная область работы прибора. Если напряжение на стоке увеличивать еще больше, то в конце концов достигается такое его значение, при котором глубина канала вблизи стока становится равной 0. Это соответствует отсечке, за которой ток стока испытывает насыщение и практически не меняет своей величины с ростом напряжения стока. Так как наибольший потенциал в канале наблюдается у стокового электрода, то перекрытие канала наступает со стороны стока. При дальнейшем повышении напряжения на стоке МОП транзистор переходит в состояние все более глубокого насыщения. Это приводит к увеличению области пространственного заряда, прилегающей к стоку, и к уменьшению длины канала. Область пространственного заряда может появиться и у истока, если подается обратное смещение на электроды исток-подложка.
Крутизна вольт-амперной характеристики МДП транзистора характеризует усилительные свойства S передаточной характеристики (рис. 3), которая выражает изменение тока от изменения входного напряжения.
 .
.
В пологой области вольтамперной характеристики крутизна равна
 .
.
Крутизна в пологой области вольтамперной этой области может быть увеличена одним из двух способов: либо уменьшением напряжения на затворе, либо изменением геометрии прибора - отношения ширины канала к его длине. Типичные значения величины крутизны для отдельных МДП маломощных полевых транзисторов лежат в пределах 0,5-12,0 мА/В.
Внутреннее или динамическое выходное сопротивление Ri определяется выражением:.

В пологой области характеристики для идеальных приборов Ri® ¥, а в реальных приборах Ri=40-100 кОм; в крутой области
Ri = L2/(mCзк(UGS – UTO – UDS))
Сопротивление затвора
Сопротивление затвора Rg является функцией напряжения на затворе UGS, напряжение на стоке Vc, порогового напряжения Vпор и имеет значение 1010 -1015 Ом.
Характеристики и параметры МДП транзисторов можно измеряют по точкам на стандартных измерительных приборах: Л2-31 - измерителях статистических параметров полевых транзисторов и Л2-32 - измерителях крутизны полевых транзисторов либо автоматически с использованием стандартного характериографа Л2-56 - измерителя характеристик полупроводниковых приборов.
7. Расчетная часть
Справочные данные:
Полевой транзистор с изолированным затвором и индуцированным каналом n- типа КП305Е
Транзистор кремниевый диффузионно-планарный полевой с изолированным затвором и каналом n-типа.
Предназначен для применения в усилительных каскадах высоких и низких частот с высоким входным сопротивлением.
Выпускаются в металлостеклянном корпусе с гибкими выводами.
Масса транзистора не более 0,7 г.

|


