Различные конфигурации КНИ МОПТ
Преимущества КНИ МОПТ
Транзисторы, изготовленные по технологии КНИ, обладают рядом важных преимуществ над транзисторами объемных технологий с аналогичной проектной нормой.
1. Область стока/истока расположена прямо над скрытым окислом, поэтому изоляция скрытым окислом имеет существенно меньшую емкость, чем изоляция pn-переходом в объемных транзисторах, что объясняется большей толщиной скрытого окисла и меньшей диэлектрической проницаемостью окисла по сравнению с кремнием. Это дает уменьшение паразитных емкостей (на 30…50%) и соответствующее увеличение быстродействия из-за уменьшения времени задержки.
2. По той же причине, из-за уменьшения паразитной емкости, уменьшается динамическое энергопотребление (приблизительно на 30% при той же тактовой частоте и напряжении питания).
3. Улучшается электростатическое качество транзисторов за счет подавления геометрических короткоканальных эффектов. Повышается (на
~ 15%) плотность интеграции за счет уменьшения расстояния между транзисторами.
4. В КНИ схемах отсутствуют эффекты влияния общей подложки на пороговые напряжения, как это имеет место в схемах объемной КМОП технологии.
5. КНИ транзисторы могут иметь очень малое (близкое к минимальному) значение подпорогового размаха (S-фактор ~ 60мВ/декаду при комнатных температурах), что позволяет снизить пороговое напряжение до 0,3В, не увеличивая статические токи утечки. Соответственно, это позволяет уменьшать напряжения питания и динамическое энергопотребление.
6. Из-за высокой степени изоляции перекрываются пути для развития паразитного тиристорного эффекта (эффекта «защелки»), часто имеющего место в n-p-n-p структурах объемных КМОП технологий.
7. Боковая изоляция (например, изоляция типа «птичий клюв» (LOCOS), мелкими канавками (STI)) дает возможность более компактного расположения элементов и более простой технологии изготовления, поскольку нет необходимости в карманах и глубоких канавках, как это имеет место в объемной технологии.
8. Отсутствуют ионизационные токи в p-n переходах при внешних импульсных ионизационных воздействиях. Поэтому КНИ МОПТ чрезвычайно устойчивы к воздействию импульсной радиации.
Толщина кремниевой базы КНИ МОПТ может быть различной. Различают КНИ структуры с толстым слоем кремния (dS > 1мкм), которые используются в мощных приборах, и тонкопленочные структуры (dS  0,2...0,3мкм), используемые в интегральных схемах высокой степени интеграции.
0,2...0,3мкм), используемые в интегральных схемах высокой степени интеграции.
Среди тонкопленочных МОПТ выделяют приборы двух типов: полностью обедненные (ПО) и частично обедненные (ЧО). Подобная классификация основана на сравнении толщины кремниевой базы dSи толщины слоя обеднения xd. Толщина слоя кремния полностью обедненной КНИ МОПТ структуры (международный термин fully depleted SOI, FD SOI MOSFET) обычно не превосходит 50 нм с типичным значением ~ 30 нм. В частично обедненных (ЧО) КНИ структурах (partially depleted SOI, PD SOI)
dS > 50 нм с типичными значениями ~ 150...200 нм. Естественным условием полного обеднения является то, что толщина обедненной области больше толщины базы xd > dS. Ясно, что выполнение этого условия зависит от уровня легирования базы. Однако в короткоканальных транзисторах условие полного обеднения зависит еще и от длины канала. Это связано с тем, что боковые обедненные области рп-переходов сток-подложка и исток-подложка увеличивают обеднение базы, существенно облегчая этот процесс. Это эквивалентно уменьшению эффективного легирования базы, которое позволяет обедненной области распространяться глубже. Чтобы эта глубина соответствовала толщине пленки, требуется увеличить концентрацию примеси в базе.
Критерием, по которому можно различать полностью и частично обедненные КНИ транзисторы, является сравнение максимальной толщины обедненной области в районе истока  и в районе стока
и в районе стока
 с толщиной слоя кремния внутренней подложки dS. При выполнении условий xd (L) < dS и xd (L) > xd (0) > dS имеем соответственно частично (PD) и полностью обедненные (FD) случаи. В промежуточном случае, когда xd(L) > dS > xd(0), говорят о тaк называемом динамическом обеднении.
с толщиной слоя кремния внутренней подложки dS. При выполнении условий xd (L) < dS и xd (L) > xd (0) > dS имеем соответственно частично (PD) и полностью обедненные (FD) случаи. В промежуточном случае, когда xd(L) > dS > xd(0), говорят о тaк называемом динамическом обеднении.
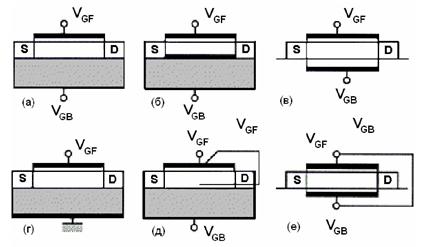
Рис. 6.2. Схематические структуры возможных конструкций КНИ МОПТ: (a) полностью обеденные, (б) транзистор с сильнолегированным дельта-слоем (pulsed doping) в кремниевой пленке, (в) с полевой обкладкой (field plate), (г) с заземленной основой (ground plane, GP), (д) динамический порог, (е) транзистор с двойным затвором.
Существуют различные варианты конфигураций КНИ МОП транзисторов (рис. 6.2), включающие в себя возможность управления напряжением как с верхнего затвора (front gate), так и со стороны подложки (нижнего затвора, back gate).
Для улучшения электростатики и повышения электростатической целостности прибора в структуру прибора можно внедрять сильнолегированные высокопроводящие слои. Они могут быть расположены непосредственно над скрытым окислом либо под ним и играть роль дополнительного управляющего затвора.