ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ
Аудит.
Правовая основа: ФЗ от 30.12.2008 г. №307-ФЗ «Об аудиторской деятельности»
=>
Задание на семинар 25.02.:
- Понятие аудита и аудиторской деятельности
- Принципы аудиторской деятельности
- Определения аудитора, индивидуального аудитора, аудиторской организации, саморегулируемой организации аудиторов, аудиторского заключения, аудиторской тайны (узнать про виды тайн, существующих в российском законодательстве)
- Виды аудита
Диодом называют полупроводниковый прибор с одним выпрямляющим переходом и двумя электрическими выводами (контактами).
 |
В качестве выпрямляющего электрического перехода (Пвып)в полупроводниковых диодах может быть использован p-n - переход (анизотипный гомо- или гетеропереход) или выпрямляющий переход металл – полупроводник (переход Шоттки). В диоде с p-n переходом или с гетеропереходом кроме выпрямляющего перехода должно быть два невыпрямляющих (омических) перехода металл – полупроводник(Пом), через которые p- и n-области диода соединены с электрическими выводами М (рис.1,а). В диоде с переходом Шоттки имется один омический переход (рис.1,б).
Обычно p-n - переход создают на основе монокристалла кремния или германия (Si и Ge – элементы IV группы), внедряя акцепторные (элементы III группы: индий, галлий, алюминий, бор) и донорные (элементы V группы: сурьма, фосфор, мышьяк) примеси. Если концентрации акцепторных Na и донорных Nd примесей равны, то p-n - переход называется симметричным. Для изготовления полупроводниковых диодов, как правило, используют несимметричные p-n - переходы. В них имеется низкоомная область эмиттера с большой концентрацией атомов примеси N = 1017¸1019 см-3 и высокоомная область базы с низкой концентрацией атомов примеси N = 1014¸1015 см-3. На рисунках эмиттерные области часто обозначают значками: p+ _ эмиттер дырок и n+ – эмиттер электронов. Так, на рис. 1, а представлен несимметричный p-n - переход с эмиттером электронов. Ток через несимметричный p-n - переход создается одним типом носителей. Вклад второго типа носителей в общий ток является несущественным.
Концентрация примесей на границе полупроводников p и n - типов может изменяться скачкообразно или плавно, соответственно такие типы p-n переходов будут называться резкими и плавными.
В зависимости от соотношения линейных размеров p-n - перехода и характеристической длины различают плоскостные и точечные диоды. Характеристической длиной для диода является наименьшая из двух величин: средняя длина диффузии неосновных носителей в базе или толщина базы. У плоскостного диода линейные размеры, значительно больше, а у точечного меньше характеристической длины.
2. ЗОННАЯ ДИАГРАММА p-n - ПЕРЕХОДА В СОСТОЯНИИ ТЕРМОДИНАМИЧЕСКОГО РАВНОВЕСИЯ
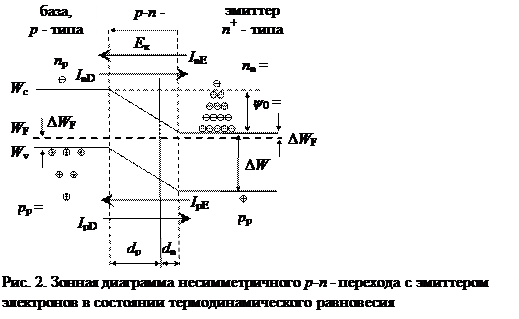 |
Зонная теория твердых тел является фундаментом для рассмотрения электрических процессов в p-n - переходе. Типичная зонная диаграмма для невырожденного несимметричного p-n - гомоперехода в состоянии термодинамического равновесия приведена на рис. 2. На рисунке отмечены уровни энергии: Wc - энергия дна зоны проводимости, Wv - энергия верха валентной зоны, WF - энергия уровня Ферми, которая в состоянии термодинамического равновесия одинакова для области p и области n, DW - ширина запрещенной зоны, DWFn - расстояние между дном зоны проводимости и уровнем Ферми в полупроводнике n - типа и DWFn - расстояние между уровнем Ферми и верхом валентной зоны и в полупроводнике p - типа.
Справа изображена высоколегированная область n+ - типа (эмиттер электронов), а слева – низколегированная область p - типа (база). Будем считать, что при температурах порядка комнатной все примеси ионизированы, концентрации тепловых электронов ni << Nd и дырок pi << Nа. Поэтому концентрация свободных электронов в области эмиттера nn = Nd, а дырок в области базы pр = Nа.
В полупроводниках идут два конкурирующих процесса: тепловой генерации и рекомбинации пар электрон – дырка. Концентрации неосновных носителей заряда nр и pn существенно меньше концентраций основных носителей pр и nn. В состоянии термодинамического равновесия
pр nр = nn pn = pi ni = Nc Nv exp(‑DW/2КТ), (1)
где pi = ni – концентрации свободных носителей заряда в чистом полупроводнике, DW – ширина запрещенной зоны (у кремния DW = 1,12 эВ, у германия DW = 0,72 эВ), Nc и Nv – эффективные плотности уровней в зоне проводимости и валентной зоне:
Nc = (2pmn*kT/h2)3/2,
Nc = (2pmp*kT/h2)3/2,
где k – постоянная Больцмана, h – постоянная Планка, mn* и mp* – эффективные массы электронов и дырок.
Как устанавливается состояние термодинамического равновесия? В упрощенном виде можно представить, что при контакте двух невырожденных полупроводников p - и n - типа (рис.2) электроны из области n диффундируют в область p и рекомбинируют с дырками. Уровень Ферми выровняется для всего полупроводника. В непосредственной близости от p-n - перехода образуются области dp в базе и dn в эмиттере, обедненные свободными носителями заряда. Однако в области dp есть неподвижные отрицательно заряженные ионы акцепторной примеси, а области dn – положительно заряженные ионы донорной примеси. Между ними возникает электрическое поле  , препятствующее дальнейшему перемещению электронов из эмиттера в базу.
, препятствующее дальнейшему перемещению электронов из эмиттера в базу.
В области p-n - перехода происходит искривление уровней энергии Wc и Wv таким образом, что в области n образуется потенциальная яма для электронов глубиной
ψ0 = qj0 = DW ‑ DWFp ‑ DWFn, (2)
где q – заряд электрона, j0 – контактная разность потенциалов. Глубина потенциальной ямы зависит от концентрации примесей. Обычно она составляет ~0,3 эВ для германиевых, ~0,6 эВ для кремниевых и ~1,0 эВ для арсенид-галлиевых диодов.
Толщина p-n перехода рассчитывается по формуле
 , (3)
, (3)
где ee0 – диэлектрическая проницаемость полупроводника.
В несимметричном p-n - переходе обедненная область d в основном располагается в области низколегированной базы. Величиной обедненной области в эмиттере, как правило, пренебрегают и считают всю обедненную область d = dp + dn ≈ dp. Обедненная область, т.е. собственно p-n - переход, является диэлектриком. Возникшие в ней тепловые электроны и дырки выталкиваются электрическим полем  в области эмиттера и базы соответственно.
в области эмиттера и базы соответственно.
Почему на рис.2 электроны в области n и дырки в области р, находящиеся в потенциальных ямах, изображены в виде пирамид? В соответствии со статистикой Ферми – Дирака вероятность заполнения энергетического уровня электроном определяется энергией W, соответствующей этому уровню, и абсолютной температурой Т:
F(W) = 1 / (1 + exp (W – WF)/KT). (4)
Максимальная концентрация свободных электронов находится практически на уровне дна зоны проводимости. Для упрощения рисунка экспоненциальный спад концентрации электронов заменен линейным. Следует отметить, что электроны в зоне проводимости совершают хаотическое тепловое движение по всему объему полупроводника n - типа и упорядоченное расположение электронов в виде пирамиды является условным, сделанным для упрощения рисунка. Аналогичные замечания относятся и к пирамиде дырок в области p.
На рис. 2 пирамида дырок у верха валентной зоны изображена более разреженной, чем пирамида электронов у дна зоны проводимости, т.к. nn >> pр.
Отношения концентраций носителей заряда одного знака по обе стороны p-n - перехода (формулы Шокли):
 ;.
;. , (6)
, (6)
где j0 – контактная разность потенциалов p-n - перехода. Величина jТ = kТ/q носит название температурный потенциал. При комнатной температуре температурный потенциал имеет значение jТ = 1,38∙10−23∙293∕1,6∙10−19 = 25∙10−3В = 25 мВ.
Свободные электроны и дырки, образовавшиеся в обедненной области в результате тепловой генерации, дрейфуют под действием электрического поля p-n - перехода в n и p - области полупроводника, создавая дрейфовые составляющие электронного InE и дырочного IрE токов. Одновременно с этим идет процесс диффузии электронов из n - области в p - область полупроводника, создающий диффузионную составляющую электронного InD и дырочного IрD токов.
В состоянии термодинамического равновесия выполняется принцип детального равновесия: электронный и дырочный токи равны нулю и общий ток также равен нулю
In = InE + InD = 0,
Iр = IрE + IрD = 0,
I = In + Iр = 0. (7)
3. ПРЯМОЕ СМЕЩЕНИЕ p–n - ПЕРЕХОДА
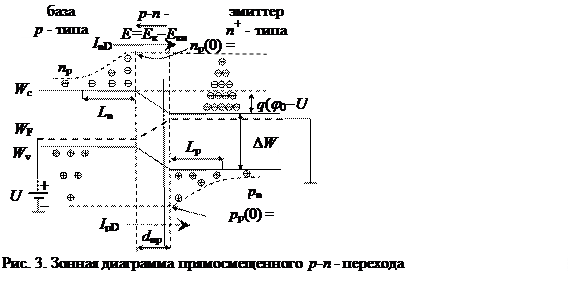 |
Зонная диаграмма прямосмещенного p-n - перехода приведена на рис.3. При прямом смещении к p-n - переходу подключается внешний источник напряжения U, плюсом к области p, минусом к области n. При этом в p-n - переходе возникает дополнительное электрическое поле
 , частично компенсирующее
, частично компенсирующее . Энергия электронов в области n увеличивается, уровень Ферми поднимается, и потенциальный барьер уменьшается до (j0 ‑ U)q, также уменьшается и толщина обедненной области
. Энергия электронов в области n увеличивается, уровень Ферми поднимается, и потенциальный барьер уменьшается до (j0 ‑ U)q, также уменьшается и толщина обедненной области
 . (8)
. (8)
Через p-n - переход протекает большой диффузионный ток, переход открыт для прохода основных носителей. Дрейфовый ток мал. В рассматриваемом случае nn >> pр, поэтому можно учитывать только диффузионную составляющую электронного тока InD.
Электроны, преодолев понизившийся потенциальный барьер, переходят в область базы, где они становятся неосновными носителями. Это биполярная инжекция, т.е. инжекция неосновных носителей, при которой знак инжектированных носителей противоположен знаку проводимости области базы. В базе концентрация электронов np(0) = npexp(U/jТ) выше равновесной, поэтому на длине диффузии Ln происходят их рекомбинации и концентрация электронов экспоненциально уменьшается до значения np в глубине базы.
При увеличении температуры p-n - перехода уменьшается высота потенциального барьера и изменяется распределение носителей заряда по энергиям (электроны, например, занимают более высокие энергетические уровни в зоне проводимости). Из-за этих двух причин прямой ток через p-n - переход увеличивается с ростом температуры при постоянном напряжении U. Если сравнить плотности прямых токов для p-n - переходов, изготовленных из материалов с разной шириной запрещенной зоны, то при большей ширине запрещенной зоны будет больше высота потенциального барьера и меньше плотность тока при одинаковом U.

4. ОБРАТНОЕ СМЕЩЕНИЕ p-n - ПЕРЕХОДА
Зонная диаграмма обратносмещенного p-n - перехода приведена на рис. 4. При обратном смещении отрицательный полюс источника напряжения U подключается к p - области, а положительный к n - области. Внешнее электрическое поле  и внутреннее
и внутреннее  совпадают по направлению. В этом случае средняя энергия электронов в области n уменьшается, уровень Ферми опускается, потенциальный барьер увеличивается до (j + U)q, а также увеличивается и толщина обедненной области
совпадают по направлению. В этом случае средняя энергия электронов в области n уменьшается, уровень Ферми опускается, потенциальный барьер увеличивается до (j + U)q, а также увеличивается и толщина обедненной области  . При этом переход электронов из области n в область p и дырок из области p в область n становится невозможен. Проводимость p-n - перехода близка к нулю. Диффузионные токи основных носителей InD = 0 и IрD = 0. Однако за счет диффузии неосновные носители подходят к краям p-n - перехода и переносятся электрическим полем
. При этом переход электронов из области n в область p и дырок из области p в область n становится невозможен. Проводимость p-n - перехода близка к нулю. Диффузионные токи основных носителей InD = 0 и IрD = 0. Однако за счет диффузии неосновные носители подходят к краям p-n - перехода и переносятся электрическим полем  +
+ через p-n - переход. Происходит экстракция неосновных носителей: электронов np из базы в эмиттер и дырок pn из эмиттера в базу. Обратносмещенный p-n - переход закрыт для основных носителей и открыт для неосновных. Через него течет малый обратный ток IS = InE + IрE.
через p-n - переход. Происходит экстракция неосновных носителей: электронов np из базы в эмиттер и дырок pn из эмиттера в базу. Обратносмещенный p-n - переход закрыт для основных носителей и открыт для неосновных. Через него течет малый обратный ток IS = InE + IрE.
За время жизни до p-n - перехода могут продифундировать неосновные носители, возникшие в n - и p - областях на расстоянии, не превышающем соответствующей диффузионной длины. Остальные неосновные носители, не успев дойти до перехода, рекомбинируют в объеме. Это справедливо для разных обратных напряжений на диоде, если толщины прилегающих к переходу областей превышают диффузионные длины неосновных носителей заряда. Поэтому обратный ток начиная с очень малых значений U не зависит от напряжения смещения. Обратный ток через диод называют тепловым током I0, он равен
 , (10)
, (10)
с учетом  и практически полной ионизации примесей при комнатной температуре
и практически полной ионизации примесей при комнатной температуре
 . (11)
. (11)
При увеличении температуры диода плотность теплового тока увеличивается, так как с температурой экспоненциально растет концентрация собственных носителей заряда (1). В диодах на основе материала с большей шириной запрещенной зоны плотность теплового тока должна быть значительно меньше, так как собственная концентрация экспоненциально уменьшается с увеличением ширины запрещенной зоны. Типичные значения плотности тока для германиевых, кремниевых и арсенид-галиевых p-n - переходов составляют: 10-5, 10-9 и 10-11 А/см2 соответственно.
5. ВОЛЬТАМПЕРНАЯ ХАРАКТЕРИСТИКА p-n - ПЕРЕХОДА