Резка монокристалла и получение пластин
Резку монокристаллов на пластины осуществляют чаще всего абразивными дисками с режущей кромкой, покрытой алмазной крошкой размером 40...60 мкм. Толщина режущей алмазной кромки диска составляет 0,18...0,20 мм, при этом ширина реза получается 0,25...0,35 мм.
Так как на поверхности пластин остаются царапины, сколы, трещины и другие дефекты, нарушающие однородность структуры поверхностного слоя, пластины шлифуют, травят и полируют. При шлифовании достигается неплос-копараллельность пластин не более 3 мкм и прогиб по поверхности не более 10 мкм. При травлении удаляется нарушенный слой толщиной 5...30 мкм и снимаются внутренние напряжения, возникшие в процессе шлифования.
Окончательная тонкая доводка поверхности пластин проводится полированием абразивными порошками или пастами, а затем химико-механическим способом с применением суспензий, золей и гелей. В результате получают полупроводниковую пластину диаметром 20...250 мм толщиной от десятков до нескольких сотен микрометров с шероховатостью обработанной поверхности не более 0,04 мкм.
7.4. Изготовление фотошаблонов
Фотошаблоны широко применяются в технологии ИМС как на стадии формирования активных элементов в полупроводниковом материале, так и при создании пассивных элементов и межсоединений.
Фотошаблон — стеклянная пластина (подложка) с нанесенным на ее поверхности маскирующим слоем — покрытием, образующим трафарет с прозрачными и непрозрачными для оптического излучения участками. В процессе фотолитографии слой фоторезиста экспонируется в соответствии с рисунком покрытия, имеющегося на фотошаблоне.
Подложку фотошаблона выполняют либо из обычного стекла (при экспонировании светом с длиной волны Я, > 300 нм), либо из кварцевого стекла (при А, < 300 нм). В качестве материала маскирующего слоя фотошаблона обычно используется хром, оксиды хрома, железа и др., образующие твердые износостойкие покрытия.
К фотошаблонам для производства полупроводниковых структур предъявляется комплекс требований, к которым в первую очередь следует отнести следующие: оптическая плотность маскирующего материала должна быть не менее 2,0; толщина маскирующего материала — не более 100 нм; его отражательная способность не выше 15 %; неплоскостность — от нескольких мкм до десятков мкм (для разных классов фотошаблонов); микродефектность порядка 0,1 см"2; краевая четкость рисунка не ниже 0,1 мкм для элементов изображения с размером менее 1 мкм.
7.5. Полупроводниковые микросхемы
Конструкция полупроводниковой МС полностью определяется ее физической структурой (совокупностью слоев в кристалле, отличающихся материалом и электрофизическими свойствами) и топологией (формой, размерами, относительным расположением отдельных областей и характером межсоединений по поверхности кристалла). Можно также сказать, что структура — это чертеж поперечного сечения кристалла ИМС, а топология — вид в плане (рис. 5 цветной вклейки).
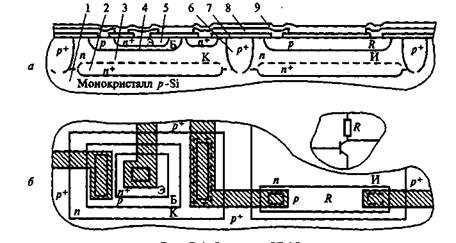
Рис.7.4. Фрагмент ИМС:
а — структура; б — топология; / — исходная монокристаллическая пластина — подложка; 2 — скрытый слой; 3 — эпитаксиальный слой (он же коллекторный); 4 — базовый слой; 5 — эмиттерный слой; 6 — разделительный слой; 7 — изолирующий слой с контактными окнами; 8 — слой металлизации; 9 — защитный слой (обычно SiCy
На рис 7.4, а приведен фрагмент структуры ИМС, представляющей собой и-/ьи-транзистор, и включенный в коллекторную цепь резистор, а на рис. 7.4, б—топология этого же участка.
Каждый из слоев 2—б представляет собой совокупность отдельных островков (областей), имеющих одинаковые толщины, тип проводимости (электронная п или дырочная р) и характер распределения примеси по толщине. Это достигается одновременным введением примеси через окна защитной маски из SiC>2, формируемой предварительно на поверхности пластины-кристалла. В отличие от слоев 2—б слои 7, 8 к 9 получают путем формирования сплошной пленки и последующего избирательного травления с использованием фотошаблона. В результате изолирующий слой 7 (SiCb) содержит контактные окна, слой металлизации 8 (обычно А1) — систему соединительных проводников и периферийные монтажные площадки, а слой 9 — окна над монтажными площадками.
Приведенная структура получила название эпитаксиалъно-планарной. Она предполагает взаимную изоляцию смежных элементов за счет обратнос-мещенных /?-«-переходов на границах изолирующего слоя. Высоколегированный скрытый слой (п+) служит для уменьшения сопротивления коллекторов транзисторов и за счет этого повышения их быстродействия. Области п+ под коллекторными контактами исключают образование потенциального барьера (барьера Шотки), обеспечивая, таким образом, омический контакт со слаболегированным коллектором, и принадлежат эмиттерному слою.

|
| Рис.7.5. Последовательность формирования топологического слоя в объеме кристалла: a — окисление поверхности; б — фотолитография; в — внедрение примеси; г — стравливание окисла |
Слои 2—б, находящиеся в объеме полупроводникового кристалла, формируются с помощью однотипного повторяющегося цикла (рис. 7.5): окисление поверхности (SiOa) — фотолитография с образованием оксидной маски — внедрение легирующей примеси через окна маски — стравливание окисла. Рисунок оксидной маски определяется рисунком фотошаблона, используемого в процессе фотолитографии. Таким образом, для создания всех слоев требуется комплект фотошаблонов с различными рисунками.
В соответствии с этим циклом последовательность формирования по-
лупроводниковой структуры следующая. В исходной пластине-подложке р-типа формируются области скрытого слоя (п+). Далее осаждается сплошной монокристаллический (эпитаксиальный) слой кремния и-типа, поверхность которого окисляется. Затем формируются области разделительного слоя (р+) с таким расчетом, чтобы они сомкнулись с подложкой. Образующиеся при этом островки эпитаксиального слоя образуют коллекторный слой (и). Внутри коллекторных областей формируются базовые ^-области (базовый слой), а внутри базовых областей — эмиттерные (эмиттерный и+-слой).
В дальнейшем обработка происходит на поверхности — формируются изолирующий слой (SiO2), слой металлизации (А1) и защитный слой (SiCh). При этом обработка осуществляется по циклу «нанесение сплошной пленки — фотолитография».
Таким образом, для получения рассматриваемой структуры необходим комплект из семи фотошаблонов.