Отверстия.
Заливка медью, ширина проводников, переходные
Маской.
Площадке, определяемой
Ния паяного соединения на
Рис. 4. Пример растрескива-
Рис. 3. Форма галтели паяного соединения шарикового вывода с контактной площадкой при различных типах площадок.
Рис. 2. Площадки, определяемые медью, и площадки, определяемые маской.
Площадки, определяемые медью. Этот тип площадок сформирован на слое меди, паяльная маска наложена с отступом от площадки. Требует меньшего размера площадки на слое меди, что позволяет осуществлять разводку проводников и переходных отверстий между ними с большим зазором металл-металл. Размеры медной площадки контролируются с гораздо большей точностью при изготовлении, чем размеры по слою паяльной маски. Финишное покрытие ложится более ровным слоем, особенно HASL. Отсутствие маски вокруг площадки позволяет шарику обтекать площадку со сторон при оплавлении, формируя более надежное паяное соединение, значительно менее подверженное разрушению от усталости при термоциклировании и механических напряжениях. Паяное соединение получается шире, с большим временем наработки на отказ, но с меньшей высотой посадки корпуса (профиля)
BGA. См. Рис. 3.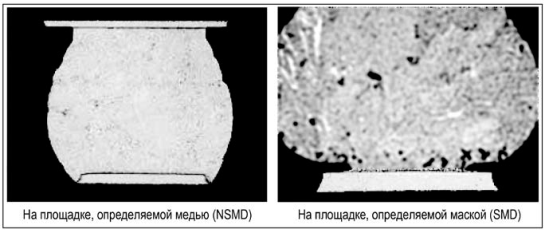
Площадки, определяемые маской. Площадки этого типа сформированы окном маски, перекрывающей большую по размеру площадку. Площадки этого типа требуют большую по меди область для получения того же размера контактной
площадки, по сравнению с площадками NSMD, оставляя меньше места для разводки. Адгезия SMD площадки к плате лучше, благодаря большему по меди размеру и перекрывающей медь маске. Посадка корпуса BGA (профиль) при оплавлении выше. Паяное соединения на этом типе площадок менее надежное, уменьшение времени наработки на отказ доходит до 70% по сравнению с NSMD площадками. В области касания оплавленного шарика с маской образуются очаги повышенного механического напряжения в циклах нагрева, охлаждения или при вибрации, по которым в последствии и происходит
растрескивание. См. Рис. 4.

Рекомендуется при проектировании всегда выбирать NSMD тип площадок (определяемые медью), как обеспечивающих большую надежность паяного соединения. Площадки, определяемые маской, стоит выбирать лишь тогда, когда очень критична высота профиля (посадки) BGA корпуса.
Использование сплошных областей заливки медью на внешнем слое под корпусом BGA микросхем считается плохим тоном. Это объясняется тем, что если контактная площадка находится на области заливки, поверхность пайки определяется не формой контактной площадки, а формой окна в паяльной маске, т.е. получается площадка, определяемая маской. То же справедливо и в случае, если ширина проводника, подходящего к контактной площадке, достаточно большая. Более того, припой будет растекаться по такому проводнику
в области, открытой из-под маски. Контактная площадка остается с недостаточным количеством припоя, шариковый вывод уменьшается в размерах, что отражается на качестве пайки контакта и надежности работы устройства. Для
предотвращения этого эффекта не следует выбирать ширину проводника более 50% от диаметра NSMD печатной площадки (согласно рекомендациям, изложенным в IPC-7095, ширина проводника, подводимого к NSMD площадке не должна превышать 0,2 мм).
Все переходные отверстия под BGA корпусом следует всегда закрывать паяльной маской. Это нужно делать для предотвращения возможного утекания припоя от контактной площадки по проводнику к открытому переходному отверстию, а также для предотвращения поднятия припоя с обратной стороны по переходному отверстию под корпус BGA (особенно при пайке волной).
Стандартным переходным отверстием для BGA с шагом 1,5 и 1,27 мм является отверстие с площадкой 0,6 мм и диаметром отверстия 0,3 мм. Для BGA с шагом 1,0 и 0,8 (0,75) мм следует использовать переходное отверстие с площадкой
0,5 мм и сверлением 0,25 мм. Для особенно узких мест можно применить переходное отверстие с предельными для сквозного механического сверления параметрами 0,45/0,2 мм. Разводка корпусов BGA с шагом менее 0,8 (0,75) мм со сквозными переходными отверстиями, изготовленными механическим
сверлением, принципиально невозможна. Для разводки таких корпусов (с шагом 0,65 мм и менее) следует применять технологию микропереходных отверстий или микропереходов (micro via). Стандартное микропереходное отверстие имеет
площадку 0,3 мм и отверстие 0,075-0,1 мм. Оно может соединять только слои 1 и 2 или n-1 и n. Возможно каскадирование микропереходов на нескольких слоях друг под другом (stacked micro via). По причине малости отверстия в микро-
переходе его можно размещать прямо на контактной площадке BGA корпуса, оставляя все свободное место между площадками для разводки проводников.
Проводники шириной 0,125 мм с таким же зазором между ними у большинства производителей в мире изготавливаются по базовой технологии и не приводят к удорожанию платы. Использование ширины проводник/зазор 0,1/0,1 мм приводит к удорожанию платы в пределах 5%-20% в зависимости от
производителя. Использование проводников менее 0,1 мм существенно удорожает печатную плату.
Перед началом работ по трассировке платы с BGA, обязательно нужно связаться с производителем печатных плат и уточнить рабочие и предельные проектные нормы на проводники, зазоры и переходные отверстия, а также процент удорожания при использовании технологий слепых/скрытых и
микропереходных отверстий, а также сверхтонких проводников.