Контроль функциональных параметров микросхем
Литография
Локальное легирование
Окисление пластин кремния
получение пленки двуокиси кремния, маскирующей поверхность кристалла
при его локальном легировании
- эпитаксиальное наращивание кремния на кремниевые и инородные подложки

- осаждение из газовой фазы
- осаждение из паровой фазы
- осаждение из растворов
получение слоев, легированными примесями
- методом диффузии
донорных и акцепторных примесей в потоке газа-носителя
(способ открытой трубы)

в кварцевую трубу направляются три потока газа:
- основной поток азота (аргона)
- слабый поток азота (аргона), прошедший через жидкий источник
- слабый поток кислорода
кислород взаимодействует с
бромистым бором с образованием окисла бора и выделением брома
кремнием с образованием окисла кремния
окисел кремния с окислом бора образует боросиликатное стекло
кремний взаимодействует с окислом бора и образует окисел
кремния и элементарный бор
(аналогично происходит с фосфором)
- методом ионного внедрения

на поверхность подложки определенной ориентации подается
пучок ускоренных ионов примеси
с энергией, достаточной для проникновения в полупроводник
- комбинированным методом
- нанесение тонких металлических пленок на пластину
получение омических контактов к слоям структуры микросхемы и
электрической разводки
- образование рисунка в маскирующих пленках для локального легирования
- образование контактных окон
- формирование рисунка электрической разводки
- фотолитография

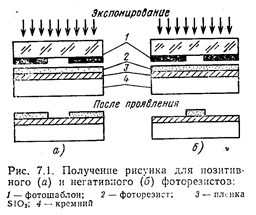
- фоторезист позитивный - пленка (после облучения) растворяется при проявлении
- фоторезист негативный - пленка (после облучения) нерастворима при проявлении
Последовательность операций:
- очистка поверхности пластин
- нанесение фоторезиста центрифугированием
- сушка слоя фоторезиста
- совмещение фотошаблона с пластиной
- экспонирование рисунка фотошаблона в слое фоторезиста
- проявление рисунка в слое фоторезиста
- задубливание фоторезиста
- травление окисла или металлизация не защищенных поверхностей
- удаление фоторезиста
- рентгенолитография
поток рентгеновских лучей направляется на шаблон, под которым
находится подложка, покрытая резистом, чувствительным к излучению
- электронолитография
- сканирующая электронная пушка с системой фокусирования формируют
остросфокусированный поток электронов с управлением от ЭВМ
- проекционная
фотокатод (источник электронов и шаблон рисунка конфигурации) освещается
ультрафиолетом участки, не защищенные пленкой, под действием
ультрафиолета испускают электроны
- ионная литография.
(комплекс операций: химическая обработка - термообработка - фотолитография):
изготовление интегральной микросхемы малой степени интеграции
на основе биполярных транзисторов с изоляцией элементов p-n переходом

изготовление изопланарной биполярной микросхемы

изготовление МОП-транзистора

- заключительные операции
- сопротивление проводников, наличие коротких замыканий и обрывов
- функционирование микросхемы по специальным тестам с использованием АСК