Современные технологии полупроводникового производства
Изготовление системы объемных выводов.
Изготовление системы ленточных перемычек.
Исходным материалом является двухслойная лента (в рулоне): алюминий толщиной 70мкм и полиимид толщиной до 100мкм. В непрерывной ленте последовательно кадр за кадром изготавливаются с помощью двухсторонней фотолитографии элементы
 |
проводящего рисунка в алюминиевой пленке и изолирующие элементы в слое полиимида.
Рис. Монтаж с помощью объемных выводов
На рис. показан пример кадра, где полиимидный рисунок зачернен и находится под проводящим рисунком. В кадре можно выделить несколько зон: зона 1 - контакты для контроля качества приварки перемычек к кристаллу (впоследствии эта зона отделяется вырубкой из кадра); зона 2 - внешние концы перемычек (впоследствии привариваются к площадкам коммутационной платы в случае большого шага их распо-ложения); зона 3 - внешние концы перемычек для плат с малым шагом размещения площадок (в этом случае зона 2 отделяется от кадра вместе с зоной 1); зона 4 - зона кристалла (показано соединение внутренних концов перемычек с монтажными площадками кристалла).
Изготовление системы перемычек производится на автоматических линиях непре-рывного действия. Лента сматывается с исходного рулона, в своем движении проходит все стадии обработки, присущие фотолитографическому процессу, через ванны, распылительные форсунки и др. устройства и в конце обработки наматывается в рулон. В позиции экспонирования очередной участок ленты (кадр) останавливается. Благодаря устройствам с накопительными петлями движение ленты на остальных позициях не прерывается.
После обработки ленту разрезают на кадры, производят совмещение внутренних концов перемычек с площадками кристалла и приваривают их, контролируют качество присоединения, отделяют зону 1 (или совместно с зоной 2), формуют перемычки, наносят клей на монтажную поверхность платы, совмещают наружные концы и приваривают их.
Для формирования объемных выводов стандартный процесс, который заканчивается осаждением защитной пленки SiO2 и образованием в ней окон над монтажными площадками, дополняется рядом операций, выполняемых в групповой пластине, т.е. до разделения ее на отдельные кристаллы.
Для будущих круглых выводов окна в защитном окисле выполняют также круглыми диаметром 70мкм. Методом осаждения в вакууме на всю поверхность пластины наносят слой ванадия (для восстановления алюминия из поверхностного окисла и уменьшения контактного сопротивления) и меди (для замыкания всех выводов и возможности последующего гальванического наращивания). Толщина каждого из слоев - несколько десятых долей мкм (рис. а). После формирования фотомаски, открывающей лишь участки будущих выводов, гальваническим методом выращивают слой меди толщиной порядка 50-60мкм. Используя ту же фотомаску, гальванически наносят слой серебра толщиной в несколько мкм. Серебро служит для защиты меди от окисления, а впоследствии - в качестве маски для стравливания тонкой меди и ванадия.

Рис. Структура жестких объемных выводов
1-алюминий, 2-двуокись кремния, 3-ванадий, 4-тонкая медь, 5-фотомаска, 6-гальваническая медь, 7-серебро, 8-припой.
Далее (рис. б) фотомаска удаляется, и последовательно стравливаются слои меди и ванадия (выводы электрически разобщаются). Наконец, горячим лужением (контакт пластины с расплавленным припоем) получают на выводах слой припоя. Во избежание растворения серебра оловом припоя в состав припоя ПОС-61 вводится за счет олова 3% серебра (припой ПСрОС-3-58).
В последние годы к стадии возможности использования в коммерческом производстве подошел целый ряд технологий, позволяющих заметно увеличить скорость работы транзисторов, либо столько же заметно уменьшить размер чипа без перехода на более тонкий технологический процесс. Некоторые из этих технологий уже начали применяться в течение последних месяцев, их названия упоминаются в новостях, относящихся к компьютерам, все чаще. Эта статья – попытка сделать краткий обзор подобных технологий, попытавшись заглянуть в самое ближайшее возможное будущее чипов, находящихся в наших компьютерах.

 Первая интегральная схема, где соединения между транзисторами сделаны прямо на подложке, была сделана более 40 лет назад. За это время технология их производства претерпела ряд больших и малых улучшений, пройдя от первой схемы Джека Килби до сегодняшних центральных процессоров, состоящих из десятков миллионов транзисторов, хотя для серверных процессоров впору уже говорить о сотнях миллионов.
Первая интегральная схема, где соединения между транзисторами сделаны прямо на подложке, была сделана более 40 лет назад. За это время технология их производства претерпела ряд больших и малых улучшений, пройдя от первой схемы Джека Килби до сегодняшних центральных процессоров, состоящих из десятков миллионов транзисторов, хотя для серверных процессоров впору уже говорить о сотнях миллионов.
Здесь пойдет речь о некоторых последних технологиях в этой области, таких, как медные проводники в чипах, SiGe, SOI, перовскиты. Но сначала необходимо в общих чертах затронуть традиционный процесс производства чипов из кремниевых пластин. Нет необходимости описывать процесс превращения песка в пластины, поскольку все эти технологии не имеют к столь базовым шагам никакого отношения, поэтому начнем с того, что мы уже имеем кремниевую пластину, диаметр которой на большинстве сегодняшних фабрик, использующих современные технологии, составляет 20 см. Ближайшим шагом на ее превращении в чипы становится процесс окисления ее поверхности, покрытия ее пленкой окислов - SiO2, являющейся прекрасным изолятором и защитой поверхности пластины при литографии.

Дальше на пластину наносится еще один защитный слой, на этот раз - светочувствительный, и происходит одна из ключевых операций - удаление в определенных местах ненужных участков его и пленки окислов с поверхности пластины, до обнажения чистого кремния, с помощью фотолитографии.
На первом этапе пластину с нанесённой на её поверхность плёнкой светочувствительного слоя помещают в установку экспонирования, которая по сути работает как фотоувеличитель. В качестве негатива здесь используется прецизионная маска - квадратная пластина кварцевого стекла покрытая плёнкой хрома там, где требуется. Хромированные и открытые участки образуют изображение одного слоя одного чипа в масштабе 1:5. По специальным знакам, заранее сформированным на поверхности пластины, установка автоматически выравнивает пластину, настраивает фокус и засвечивает светочувствительный слой через маску и систему линз с уменьшением так, что на пластине получается изображение кристалла в масштабе 1:1. Затем пластина сдвигается, экспонируется следующий кристалл и так далее, пока не обработаются все чипы на пластине. Сама маска тоже формируется фотохимическим способом, только засвечивание светочувствительного слоя при формировании маски происходит по программе электронным лучом примерно также, как в телевизионном кинескопе.
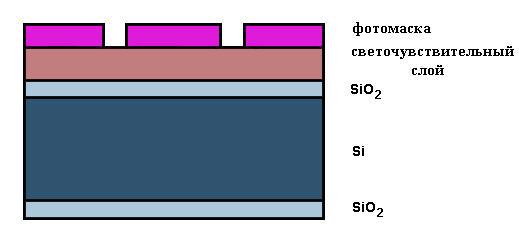
В результате засвечивания химический состав тех участков светочувствительного слоя, которые попали под прозрачные области фотомаски, меняется. Что дает возможность удалить их с помощью соответствующих химикатов или других методов, вроде плазмы или рентгеновских лучей.

После чего аналогичной процедуре (уже с использованием других веществ, разумеется) подвергается и слой окислов на поверхности пластины. И снова, опять же, уже новыми химикатами, снимается светочувствительный слой:

Потом накладывается следующая маска, уже с другим шаблоном, потом еще одна, еще, и еще... Именно этот этап производства чипа является критическим в плане ошибок: любая пылинка или микроскопический сдвиг в сторону при наложении очередной маски, и чип уже может отправиться на свалку. После того, как сформирована структура чипа, пришло время для изменения атомной структуры кремния в необходимых участках путем добавления различных примесей. Это требуется для того, чтобы получить области кремния с различными электрическими свойствами - p-типа и n-типа, то есть, как раз то, что требуется для создания транзистора. Для формирования p-областей используются бор, галлий, алюминий, для создания n-областей - сурьма, мышьяк, фосфор.
Поверхность пластины тщательно очищается, чтобы вместе с примесями в кремний не попали лишние вещества, после чего она попадает в камеру для высокотемпературной обработки и на нее, в том или ином агрегатном состоянии, с использованием ионизации или без, наносится небольшое количество требуемых примесей. После чего, при температуре порядка от 700 до 1400 градусов, происходит процесс диффузии, проникновения требуемых элементов в кремний на его открытых в процессе литографии участках. В результате на поверхности пластины получаются участки с нужными свойствами. И в конце этого этапа на их поверхность наносится все та же защитная пленка из окисла кремния, толщиной порядка одного микрона.

Все. Осталось только проложить по поверхности чипа металлические соединения (сегодня для этой роли обычно используется алюминий, а соединения сегодня обычно расположены в 6 слоев), и дело сделано. В общих чертах, так в результате и получается, к примеру, классический МОП транзистор: при наличии напряжения на затворе начинается перемещение электронов между измененными областями кремния.

Теперь, слегка пробежавшись по классическому процессу создания сегодняшних чипов, можно более уверенно перейти к обзору технологий, которые предполагают внести определенные коррективы в эту картину.