Носители заряда в примесных полупроводниках
При производстве полупроводниковых приборов помимо чистых полупроводников, в частности, чистых германия и кремния, являющихся исходными материалами, используют примесные полупроводники.
Введение примеси связано с необходимостью создания в полупроводнике преимущественно электронной либо дырочной электропроводности и увеличения электрической проводимости. В связи с этим различают соответственно электронные (n-типа) и дырочные (р-типа) полупроводники.
Для получения полупроводника с электропроводностью n-типа в чистый полупроводник вводят примесь, создающую в полупроводнике только свободные электроны. Вводимая примесь является "поставщиком" электронов, поэтому ее называют донорной. Для германия и кремния, относящихся к IV группе Периодической системы элементов, донорной примесью служат элементы V группы (сурьма, фосфор, мышьяк), атомы которых имеют пять валентных электронов.
При внесении такой примеси атомы примеси замещают атомы исходного полупроводника в отдельных узлах кристаллической решетки (рисунок 1.5, а).
Четыре электрона каждого атома донорной примеси участвуют в ковалентной связи с соседними атомами исходного материала, а пятый ("избыточный") электрон, не участвующий в ковалентной связи, оказывается значительно слабее связанным со своим атомом. Для того чтобы оторвать его от атома и превратить в свободный носитель заряда, требуется значительно меньшее количество энергии, чем для освобождения электрона из ковалентной связи. В результате приобретения такой энергии (например, энергии фонона при комнатной температуре кристалла) "избыточный" электрон покидает атом и становится свободным, а атом примеси превращается в положительный ион (ионизация атома примеси).
В условиях достаточно большой концентрации атомов примеси их ионизация создает некоторую концентрацию в кристалле полупроводника свободных электронов и неподвижных положительных ионов, локализованных в местах расположения атомов примеси. Слой полупроводника остается элект рически нейтральным, если освободившиеся электроны не уходят за пределы слоя. При уходе электронов под воздействием каких-либо факторов в другие
слои кристалла, оставшиеся положительные ионы донорной примеси создают в данном слое нескомпенсированный положительный объемный заряд.
На энергетической диаграмме полупроводника n-типа (рисунок 1.5, б) вводимая примесь приводит к появлению в запрещенной зоне вблизи зоны проводимости близко расположенных друг от друга локальных валентных уровней энергии, заполненных электронами при температуре абсолютного нуля.

Рисунок 1.5 - Возникновение свободного электрона в кристалле полупроводника
n-типа (а) и отражение этого процесса на энергетической диаграмме (б)
Число локальных уровней определяется количеством атомов примеси в кристалле. На рисунке 1.5, б локальные уровни показаны пунктиром. Так как ширина ΔWД мала (в зависимости от типа исходного полупроводника и материала донорной примеси ΔWД = 0,01…0,07 эВ), при комнатной температуре практически все электроны донорных уровней перейдут в зону проводимости и смогут участвовать в создании тока.
Концентрация свободных электронов в зоне проводимости при этом определяется преимущественно концентрацией введенной примеси NД, а не собственными электронами валентной зоны, преодолевающими широкую запрещенную зону ΔWЗ. В соответствии с этим концентрация электронов nn в полупроводнике n-типа существенно выше концентрации дырок pn, образующейся в результате перехода электронов из валентной зоны в зону проводимости. Можно считать, что в полупроводнике n-типа ток создается в основном электронами. Другими словами, электроны в этом случае являются основными носителями заряда, а дырки — неосновными носителями заряда.
В полупроводниках p-типа введение примеси направлено на повышение концентрации дырок. Задача решается использованием в качестве примеси элементов III группы Периодической системы (индий, алюминий, бор), атомы которых имеют по три валентных электрона. При наличии такой примеси каждый ее атом образует только три заполненные ковалентные связи с соседними атомами исходного полупроводника в кристаллической решетке (рисунок 1.6, а). Четвертая связь остается незаполненной. Недостающий валентный электрон для заполнения связи переходит от одного из соседних атомов кристаллической решетки, так как требуемая для такого перехода энергия невелика. Переход электрона приводит к образованию дырки в ковалентной связи соседнего атома, откуда ушел электрон, и превращению атома примеси в неподвижный отрицательный ион. В результате за счет примеси достигается повышение концентрации дырок в полупроводнике. Атомы примеси, принимающие валентные электроны соседних атомов, называют акцепторными, а саму примесь — акцепторной.
В условиях достаточно большой концентрации атомов акцепторной примеси в кристалле полупроводника создается некоторая концентрация дырок и отрицательных ионов. Пока число дырок в данном слое полупроводника остается равным числу отрицательных ионов в нем, в слое сохраняется зарядная нейтральность. Если вошедшие из других слоев электроны заполнят некоторое число существующих дефектов валентной связи (рекомбинация электронов с дырками), в данном слое появится нескомпенсированный отрицательный объемный заряд, создаваемый ионами акцепторной примеси.
Рассмотрим процесс образования дырок в полупроводнике р-типа, исходя из его энергетической диаграммы. При наличии акцепторной примеси в запрещенной зоне энергетической диаграммы исходного полупроводника вблизи валентной зоны появляются локальные уровни энергии, свободные от электронов при температуре абсолютного нуля (рисунок 1.6, б). Число локальных уровней определяется концентрацией атомов примеси в кристалле. Так как разность ΔWА между энергией акцепторных уровней и энергией верхнего уровня валентной зоны мала (в зависимости от типа полупроводника и материала акцепторной примеси ΔWА = 0,01...0,07 эВ), то при комнатной температуре все акцепторные уровни будут заняты электронами, перешедшими из валентной зоны. В валентной зоне появится большая концентрация дырок.
Концентрация дырок в валентной зоне при этом определяется преимущественно концентрацией внесенной акцепторной примеси Na, а не дырками, возникающими при термогенерации носителей заряда за счет преодоления валентными электронами широкой запрещенной зоны ΔWЗ. В соответствии с этим концентрация дырок рp в полупроводнике р-типа существенно больше концентрации свободных электронов np. По этой причине ток в дырочном полупроводнике переносится в основном дырками. Дырки в этом случае являются основными носителями заряда, а электроны — неосновными.
Таким образом, в примесных полупроводниках концентрации основных носителей заряда (nn- электронного полупроводника и pp - дырочного полупроводника) создаются за счет внесения примеси, а концентрации неосновных носителей заряда (pn, np - соответственно электронного и дырочного полупроводников) — за счет термогенерации носителей заря да, связанной с переходом элек-
return false">ссылка скрыта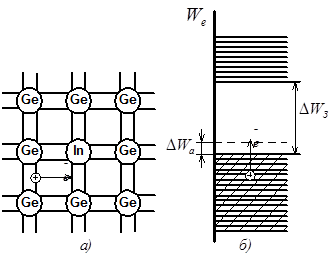
Рисунок 1.6 - Возникновение дырки в кристалле полупроводника р-типа (а) и отражение этого процесса на энергетической диаграмме (б)
тронов из валент-ной зоны в зону проводимости. Примесь вносится в количестве, при котором концентрация основных носителей заряда существенно (на два – три порядка) превышает концентрацию неосновных носителей заряда. В зависимости от концентрации введенной примеси удельная проводимость примесного полупроводника возрастает по сравнению с чистым полупроводником в десятки и сотни тысяч раз.
Характерной особенностью полупроводников рассматриваемых типов является то, что произведение концентраций основных и неосновных носителей заряда при данной температуре является постоянной величиной и определяется соотношением:

| (1.2) |
где ni = pi – собственные концентрации носителей заряда в чистом полупроводнике.
В соответствии с выражением (1.2) концентрация неосновных носителей заряда в примесном полупроводнике меньше концентрации собственных носителей заряда в чистом полупроводнике. Это связано с тем, что с увеличением концентрации основных носителей заряда возрастает роль рекомбинаций, вследствие чего концентрация неосновных носителей заряда уменьшается. Равновесие достигается, когда при данной температуре произведение концентраций носителей заряда в примесном полупроводнике становится равным произведению концентраций носителей заряда в чистом полупроводнике.
Зависимость концентрации носителей заряда от температуры накладывает ограничения на температурный диапазон применения полупроводниковых приборов. Рабочий диапазон температур характеризуется существенным превышением в примесных полупроводниках концентрации основных носителей заряда над неосновными (nn » pn и рp » np) при концентрации основных носителей заряда, близкой к концентрации внесенной примеси (nn ≈ NД и
рp ≈ NА).
При температурах, превышающих верхний температурный предел, причиной нарушения условия nn » pn , рp » np является повышение роли концентрации носителей заряда, создаваемых в кристалле при термогенерации за счет преодоления валентными электронами запрещенной зоны ΔWЗ. При этом может оказаться, что концентрация носителей заряда и электрическая проводимость в полупроводнике будут определяться не концентрацией внесенной примеси, а концентрацией собственных носителей заряда — электронов и дырок (вырождение примесного полупроводника в собственно полупроводник). Верхний температурный предел зависит от ширины запрещенной зоны полупроводника и составляет для германия 75°…85°С, а для кремния 150°…170°С. В этом проявляется существенное преимущество кремния как материала для полупроводниковых приборов.
При температуре ниже рабочего диапазона концентрация неосновных носителей заряда, создаваемая термогенерацией, ничтожно мала. Основную роль здесь играет понижение концентрации основных носителей заряда (и уменьшение электрической проводимости) вследствие уменьшения количества ионизированных атомов примеси. Нижний температурный предел работы полупроводниковых приборов составляет от минус 55° до минус 60°С.