Методические указания
Некоммерческое акционерное общество
Алматинский университет энергетики и связи
Факультет аэрокосмических и информационных технологий
Кафедра электроники
ТЕХНОЛОГИЯ МАТЕРИАЛОВ И ИЗДЕЛИЙ
ЭЛЕКТРОННОЙ ТЕХНИКИ
Методические указания к выполнению расчетно-графических работ
для студентов всех форм обучения специальности
5В071600 - Приборостроение
Алматы 2014
СОСТАВИТЕЛЬ: Туякбаев А.А. Технология материалов и изделий электронной техники. Методические указания к выполнению расчетно-графических работ и контрольные задания для студентов всех форм обучения специальности 5В071600 – Приборостроение. - Алматы: АУЭС, 2014.- 15 с.
Методические указания содержат основные требования к выполнению расчетно-графических работ.
РГР №1
Рассчитать профиль легирования примесей эпитаксиально-планарных транзисторов для исходных данных, определяемых по последней цифре зачетной книжки (табл.1).
Таблица 1
| № варианта | Темп. загонки бора в оС | Время загонки бора в мин. | Темп. разгонки бора в оС | Время разгонки бора в мин. | Темп. загонки фосфора в оС | Время загонки фосфора в мин. | Темп. разгонки фосфора в оС | Время разгонки фосфора в мин. |
Построить на миллиметровой бумаге или с помощью компьютера рассчитанный профиль легирования эпитаксиально-планарного транзистора.
Примечание: недостающие для расчета параметры из справочных данных выбираются студентом самостоятельно.
Методические указания
Современные твердотельные интегральные транзисторы изготавливаются методами планарной или изопланарной технологий, часто с использованием и лучевых технологий [2, 3] . Современные транзисторы характеризуются тем, что области базы и эмиттера получают последовательной направленной локальной диффузией (обычно бора и фосфора соответственно) на эпитаксиально выращенный на подложке кремниевый коллекторный слой n - типа. Благодаря большей простоте производства в интегральной схемотехнике преобладающее распространение получили транзисторы типа n-р-n по сравнению с р-n-р транзисторами.
Исходным материалом при изготовлении планарного транзистора служит кремниевая подложка с выращенной на ней эпитаксиальной пленкой n - кремния - для транзистора с высокоомным коллектором, либо n – n+ - структуры - для транзисторов с низкоомным коллектором [1, 2, 3, 4] . Наибольшее распространение при выращивании эпитаксиальных пленок получили методы водородного восстановления трихлорсилана, водородного восстановления тетрахлорида кремния и термического разложения моносилана [3]. Низкие скорости выращивания эпитаксиальных пленок обеспечивают равномерную концентрацию примесей в коллекторе транзистора. После этого происходит маскировка окисной пленкой и получение на ней вытравленных окон, в которые при высокой температуре осуществляется направленная диффузия акцепторных примесей (например, бора) для создания базовой области. Диффузия бора обычно протекает в две стадии. Первая стадия диффузии (загонка) ведется при температуре (900 - 1050°С) в течение от минут до 1 часа. При этом создается большая поверхностная концентрация атомов бора на поверхности кремния, близкая к предельной растворимости бора в кремнии при температуре диффузии.
После загонки бора пленку боросиликатного стекла снимают в растворе на основе плавиковой кислоты, пластины промывают в деионизованыой воде и загружают в печь для проведения второй стадии диффузии - перераспределения примесей одновременно с окислением (разгонка).
Разгонка бора проводится при температуре (1050 - 1250°С) в течение нескольких часов (от двух и более). При этом весь процесс протекает в окислительной среде, т.е. используется кислородная атмосфера с увлажнением и без увлажнения.
Поверхность, на которой эпитаксиальная донорная концентрация равна диффузионной акцепторной концентрации называется металлургической границей коллекторного р-n перехода
NDK (xко) – NA (xко) = 0 . (1)
После этого производится вторая фотолитографическая обработка, при которой локализуются будущие эмиттерные области. В полученные окна проводят диффузию фосфора. При изготовлении высокочастотных транзисторов диффузия фосфора также осуществляется в две стадии. Загонка проводится при температуре (870 - 1150°С), а разгонка при (1000 - 1150°С).
При этом следует отметить, что для каждого конкретного типа транзистора диффузионные температурные режимы задаются с точностью ±1°С . Временные режимы должны быть также достаточно точны для получения хорошей воспроизводимости.
Металлургической границей эмиттерного р-n перехода xэо будет поверхность, на которой диффузионная донорная концентрация равна диффузионной акцепторной концентрации [5]
NDЭ (xэо) – NA (xэо) = 0 . (2)
Строго говоря, при точном определении металлургической границы эмиттерного р-n перехода xэо необходимо учитывать и эпитаксиальную донорную концентрацию коллектора, т.е. вместо (2) пользоваться выражением
NDЭ (xко  ) – NA (xэо
) – NA (xэо  ) + NDK = 0 , (3)
) + NDK = 0 , (3)
а при определении металлургической границы коллекторного р-n перехода учитывать диффузионную составляющую донорной концентрации примеси
NDЭ (xко  ) + NDK – NA (xко
) + NDK – NA (xко  ) = 0 . (4)
) = 0 . (4)
Рассмотрим теперь распределение концентрации диффузионных примесей. Общеизвестно, что концентрация диффузионных примесей уменьшается по мере удаления от поверхности [2, 4 - 9] .
Для анализа распределения диффузионной концентрации (диффузионного профиля) необходимо решить дифференциальное уравнение, называемое вторым законом Фика [5, 10]
 = D
= D  , (5)
, (5)
где зависимость коэффициента диффузии D от температуры определяется из выражения
D = Do exp (–  ) . (6)
) . (6)
где ΔH – энергия активации; К – постоянная Больцмана; Т – абсолютная температура; Do – постоянная, зависящая от вида полупроводникового материала и диффузанта.
Значения ΔH и Do определяются экспериментально и приведены в [5, 10, 11]
Общее решение уравнения (5) имеет вид [5]
N(x,t) =  , (7)
, (7)
где  - текущая координата интегрирования;
- текущая координата интегрирования;
f(  ) - начальное распределение концентраций, равное: N(x, 0).
) - начальное распределение концентраций, равное: N(x, 0).
Наибольший практический интерес представляют два частных случая этого решения, которые могут характеризовать две стадии диффузии, применяемые в планарной технологии изготовления транзисторов.
Первый случай, соответствующий "загонке" примеси, представляет собой диффузию от поверхности постоянной концентрации: обычно в литературе его называют случаем диффузии из бесконечного источника [5, 12] . Граничные условия в этом случае имеют вид N(0,t) = Ns . Начальная концентрация во всем теле равна нулю. Решение задачи в этом случае для полуограниченного тела принимает вид [5]
N(x,t) = Ns erfc  , (8)
, (8)
где erfc(х/(2•√D•t)) = 1 –  – дополнительная функция ошибок.
– дополнительная функция ошибок.
Рассмотренный пример реализуется при больших глубинах диффузии и малых поверхностных концентрациях, когда коэффициент диффузии не зависит от концентрации и, следовательно, от координаты х . В работе [5] показано, что при поверхностных концентрациях бора менее 6 • 1019 см-3 распределение бора при диффузии подчиняется закону дополнительной функции ошибок (8). При Ns > 6•I019см-3 коэффициент диффузии D становится непостоянным и растет, что приводит к появлению участка с почти постоянной концентрацией на кривых N = N(x).
Во многих практических случаях важно знать количество диффузанта, проникшего в тело за время диффузии. Эта величина может быть определена по формуле [12]
Q = ∫ j(0,t) dt ,
где j(0,t) – поток диффузанта в объем тела, равный
j(0,t) = Ns•(D/(π•t))½ .
Интегрируя полученное выражение по времени, получим
Q = Ns/(π)½•(2•(D•t)½) .
Данное выражение позволяет определять количество диффузанта при загонке примеси.
При разгонке перераспределение примесей можно использовать следующее выражение
N(x,t) = Ns/2•[erf((h – x/(2•(D•t)½)) + erf((h + x/(2•(D•t)½))] .
В данном случае диффузия ведется из ограниченного источника диффузанта. Количество диффузанта, равное Q = Ns•h , в процессе диффузии остается неизменным. Происходит перераспределение примеси по объему тела. Если толщину слоя h устремить к нулю, то получим распределение примеси при диффузии из бесконечно тонкого слоя в полуограниченное тело с отражающей границей. Если полагать, что с устремлением h к нулю количество диффузанта Q в слое остается неизменным, то распределение примеси запишется
N(x,t) = Q/(π• D•t)½•exp(-x2/(4• D•t)).
Данное выражение в достаточной степени точно позволяет рассчитывать профиль легирования примесей при тех или иных технологических режимах. Однако это выражение не учитывает то, что происходит перераспределение примеси между кремнием и окисным слоем.
Профиль легирования примесей более точно можно рассчитать, используя модель Кейва [13]
N2(y*,t) = (1/(2•√π))•Nso•exp[-(y*+0,22•хSiO/L2)2]•[(1/(√gt2 − y*) – 1/(2•(√gt2 − y*)3) + (√gt2+c•√D2•t2)/(√gt2−c•√D2•t2)•( 1/(√gt2 + y*) – 1/(2•(√gt2 + y*)3) – (2•c•√D2•t2)/(gt2−c•√D2•t2)•(1/(c•√D2•t2 + y*) – 1/(2•(c•√D2•t2 + y*)3)] ,
где y* = у/(2•√D2•t2) ,
L2 = √D2•t2 – диффузионная длина примесей при разгонке;
√gt2 = (L2/L1)•[1−0,22•(хSiO/L2)• (L2/L1)] ,
c•√D2•t2 = (хSiO/L2)•Ks•(1−0,22/Ks) ,
L1 = √D1•t1 – диффузионная длина примесей при загонке;
Ks – коэффициент сегрегации, представляющий собой отношение концентрации примеси, внедрившейся в окисел, к концентрации оставшихся примесей в кремнии на границе раздела с окислом, который для бора Ks=3,
Nso = 2•1020см-3 .
Для определения диффузионных профилей фосфора наиболее точной считается модель Тсай [9] , в которой этот профиль разделяется на три области. Первая состоит из кремния, насыщенного фосфидом кремния и ионизированным фосфором. Толщина этой области хо определяется временем диффузии
хо = λ•t ,
где λ – коэффициент пропорциональности, величина которого зависит от температуры и определено было экспериментально.
В таблице 1 приведены значения λ для различных температур диффузии в кремний фосфора.
Таблица 1.
| ТоС | ||||||
| λ | 1,33•10-5 | 4,85•10-5 | 1,03•10-4 | 1,68•10-4 | 3,34•10-4 | 8,34•10-4 |
Вторая область состоит из медленно диффундирующего фосфида кремния, характеризующегося коэффициентом диффузии DA и быстро диффундирующего фосфора с коэффициентом диффузии DB . Третья область состоит из быстро диффундирующего фосфора с коэффициентом диффузии DB . Тогда выражение для концентрации примесей имеет вид
Ns при х < хо
N(x) = {
N*(x) при х > хо ,
где
N*(x) = (Ns − Nв)/2•exp[−(λ•(x – хо))/(2•DA)]•{erfc[(x + хо)/(2•√DA•t)] +
erfc[(x − 3хо)/(2•√DA•t)]} + Nв/2•exp[−(λ•(x – хо))/(2•DB)]•
{erfc[(x − хо)/(2•√DB•t)] + erfc[(x − 3хо)/(2•√DB•t)]} .
За NВ обозначена концентрация быстро диффундирующего фосфора на удалении хо от поверхности кристалла. Значения Nв , Ns , DA , DB были определены Тсай для различных температур диффузии. Для поверхностной концентрации Ns = 4•1020см-3 в таблице 2 приведены значения Nв , DA , DB в зависимости от температуры диффузии ТоК .
Таблица 2.
| ТоК | ||||||
| Nв = 1019 см-3 | 3,5 | |||||
| DA = 10-16 см2/сек | ||||||
| DB = 10-15 см2/сек |
Таким образом, эти модели Тсай позволяют определять диффузионный профиль фосфора при процессе загонки. При процессе разгонки перераспределение фосфора можно определять также, как и в случае с бором, только значение коэффициента сегрегации Ks принимать равным 0,1 ÷ 0,001 [5] .
Примерный профиль легирования эпитаксиально-планарного n-p-n транзистора приведен на рис.1. За xm обозначен максимум результирующей концентрации в базе р–типа. Он находится из условия
 (9)
(9)
За x'  и x''
и x''  обозначены границы эмиттерного р-п перехода с квазинейтральными слоями эмиттера и базы. За x'к и x''к обозначены границы коллекторного перехода с квазинейтральными слоями базы и коллектора соответственно. Для расчета этих границ можно воспользоваться соотношениями [5, 17, 18]
обозначены границы эмиттерного р-п перехода с квазинейтральными слоями эмиттера и базы. За x'к и x''к обозначены границы коллекторного перехода с квазинейтральными слоями базы и коллектора соответственно. Для расчета этих границ можно воспользоваться соотношениями [5, 17, 18]
xко – x'к = LA ln  , (10)
, (10)
где Δφok - контактная разность потенциалов коллекторного перехода, которая
определяется из соотношения
Δφok = φт ln  , (11)
, (11)
Uk - напряжение на коллекторном переходе;
LA - характеристическая длина в распределении акцепторов, которая
находится из соотношения
LA =  , (12)
, (12)
ωбо – металлургическая толщина базы
ωбо = хко – хэо , (13)
ε – диэлектрическая постоянная для кремния ε = 12 .
εо – диэлектрическая проницаемость вакуума
εо = 8,85 ·10-14 Ф/см .
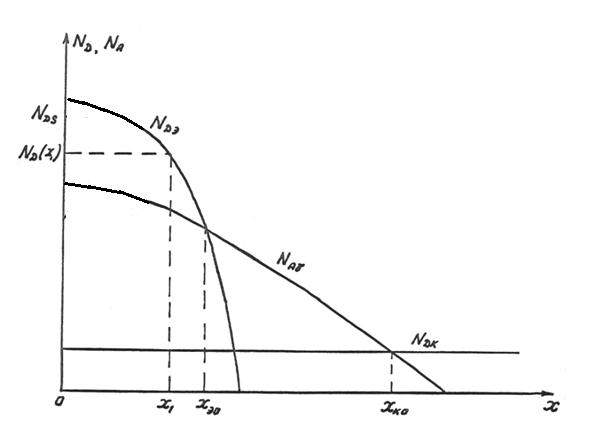
Рис.1. Результирующий диффузионный профиль эпитаксиально-планарного транзистора.
Значение толщины коллекторного перехода при обратных смещениях находится из выражения [5]:
xк′′ − хк′ = Lкр-n = LA +  . (14)
. (14)
Так как эмиттерный переход при прямых смещениях можно считать плавным, то можно записать для толщины эмиттерного перехода [5,12]
xэ′′ − хэ′ = Lэр-n = 
 , (15)
, (15)
xэ′′ − хэо =  Lэр-n ,
Lэр-n ,
где uэ – напряжение на эмиттерном переходе;
 – контактная разность потенциалов эмиттерного перехода, которая определяется из соотношения
– контактная разность потенциалов эмиттерного перехода, которая определяется из соотношения
 =
=  , (16)
, (16)
где pp(xэ′′) = NA(xэ′′) – ND(xэ′′) ,
nn(хэ′) = ND(хэ′) – NA(хэ′).
В активном инверсном включении коллекторный переход находится в прямом смещении, а эмиттерный – в обратном. В этом случае коллекторный переход можно считать плавным и ширину перехода рассчитывать по формуле
xк′′ − хк′ = Lкр-n = 
 , (17)
, (17)
а эмиттерный переход резким [39]
xэ′′ − хэ′ = Lэр-n =  , (18)
, (18)
xэ′′ − хэо = Lэр-n•  , (19)
, (19)
где nnoэ – среднее значение равновесной концентрации основных носителей в эмиттере;
рроб – среднее значение равновесной концентрации основных носителей в базе.
РГР №2
Рассчитать электрическое поле в базе эпитаксиально-планарных
транзисторов по данным, полученным в РГР №1.
Методика расчета электрического поля в базе
эпитаксиально-планарных транзисторов
В результате диффузии распределение результирующей концентрации примесей имеет вид, представленный на рис.1. Вследствие этого дырки в базе будут диффундировать из области с повышенным распределением акцепторов (х = хm) к обоим р-n переходам. У металлургических границ обоих р-n переходов появится избыточный объемный положительный заряд, а при (х=хm) появится избыточный объемный отрицательный заряд. Таким образом при отсутствии смещений на обоих р-n переходах в базе образуется внутреннее электрическое поле.
Как видно из рис.1 для нормального активного режима транзистора электрическое поле в базе на участке (хэо, хm) является тормозящим для неосновных носителей - электронов, инжектированных в базу из эмиттера, а на участке (хm, хко) - ускоряющим. Для повышения эффективности работы транзистора стремятся уменьшить тормозящий участок поля. На практике обычно (хm– хэо)/ωбо = 0,08 – 0,15 по результатам работ Редди [19]. Для инверсного включения получим, что на участке (хm, хко) электрическое поле для неосновных носителей - электронов, инжектированных в базу из коллектора является тормозящим, а на участке (хm, хэо) – ускоряющим. Таким образом, при работе в нормальном активном включении ускоряющее электрическое поле в базе действует на большем участке, чем тормозящее, а при инверсном включении наблюдается обратный эффект.
Исследованию влияния электрического поля в базе на процессы переноса носителей посвящено много работ [5, 20, 22, 23]. Напряженность поля на участке (хm, хко) оказывается непостоянной: она почти линейно возрастает от эмиттера к коллектору
Eo(x) = Eoэm [1 – (x – хm)/(2LD)] , (1)
где Е oэm - напряженность поля в базе у эмиттерного перехода у точки хm ;
LD - длина диффузии примесей.
В работе [22] показано, что значения параметров транзистора, полученные при точных расчетах напряженности поля в базе, мало отличаются от значений параметров, полученных при использовании среднего значения напряженности поля в базе, которое получается при допущении, что примеси в базе распределяются по экспоненциальному закону
Eo ≈ φт  =
=  . (2)
. (2)
Литература
1. Линн Д., Мейер Ч., Гамильтон Д. Анализ и расчет интегральных схем. Перевод с англ., изд-во "Мир", Москва, 1969 г.
2. Основы технологии кремниевых интегральных схем. Окисление, диффузия, эпитаксия. Под ред. Бургера Р., Донована Р. Перевод с англ. под ред. Мордковича. В.Н., Пресса Ф.П., Москва, "Мир", 1969 г.
3. Алексеенко А.Г. Основы микросхемотехники. Москва, Изд-во "Советское радио", 1971 г.
4. Dobkin R.C. New Developments in monolithic Op Amps. – «Electronics World», 1970, vol.84, №1, p. 45-48.
5. Кремниевые планарные транзисторы. Под, ред. Федотова Я.А Москва, "Советское радио", 1973 г.
6. Зи С.М. Физика полупроводниковых приборов. Перевод с англ. под ред. Трутко А.Ф. Москва, "Энергия", 1973 г.
7. Мэдленд Г.Р., Дикеи Г.К., Ричардсон Р.Д., Боуер Ф.Т., Крет Д„Г. Интегральные схемы. Основы проектирования и технологии. Перевод с англ. под ред. Мартюшова К.Н., Москва, Изд-во "Советское радио", 1970 г.
8. Ргitchord R.L. Electrical Characteristics of transistors. Mc. Graw – Hill Book Company. New york, 1967.
9. Tcaй К. Неглубокие диффузионные слои фосфора в кремнии. "ТИИЭР", 1969 г., т. 57, № 9. стр. 38 - 46.
10. Fuller C.S., Ditzenberger J.A. Diffusion of Donor and acceptor elements in silicon. – «Journal of applied physics». 1956, vol. 27, N5, p.544-553.
11. Fuller C.S., Ditzenberger J.A. Diffusion of boron and phosphorus into silicon. – «Journal of applied physics». 1954, vol. 25, N11, p.1439-1440.
12. Новиков Б.В. Теоретические основы микроэлектроники.
ИЗД-во "Высшая школа", Москва, 1972 г.
13. Cave K.I.S. The base diffusion prodile arising from boron redistribution in the oxide – a useful approximation. – «Solid state Electronics», 1965, vol.8, N12, p.991-993.
14. Chang J.J. Consentration – dependent diffusion of Boron and phosphorus in silicon. – «IEEE Transactions on Electron Devices», 1963, vol.ED-10, N6, p.357-359.
15. Kato T., Nishi Y. Redistribution of diffused boron in silicon by thermal oxidation. – «Japanese journal of applied physics», 1967, vol.3, N7, p.377-383.
16. Chen W.H., Chen W.S. Impurity redistribution in a semiconductor during thermal oxidation, – «Journal of Electrochemical Society», 1967, vol.114, N12, p.1297-1303.
18. Пикус Г.E.Основы теории полупроводниковых приборов. Москва, Изд-во "Наука", 1965 г.
19. Колосов А.А., Горбунов Ю.Н., Наумов Ю.Е. Полупроводниковые твердые схемы. Москва, Изд-во "Советское радио", 1965 г.
20. Reddy V.G.K. Influence of surface conditions on silicon planar transistor current gain. – «Solid state Electronics», 1967, vol.10, N4, p.305-334.
21. Болтакс Б.И. Диффузия в полупроводниках. Москва, Физматгиз, 1961.
22. Спиридонов Н.С. Основы теории транзисторов» изд-во "Техника", Киев, 1975 г.
23. Галицкий В.В. Переходные характеристики транзистора с изменяющимся вдоль базы электрическим полем. М.:-Известия вузов. Радиотехника», 1964 г, стр. 472 - 479.