Эффект поля. Полевые транзисторы
Изгиб зон и избыточную проводимость, описанные выше, можно получить и с помощью внешнего поля, перпендикулярного поверхности полупроводника. Более того, оказалось, что с помощью внешнего поля можно изменять величину и знак потенциального барьера в ОПЗ, тем самым изменяя поверхностную проводимость. Это была чрезвычайно плодотворная идея. На ее основе созданы полевые транзисторы и интегральные схемы на полевых транзисторах, разработана область функциональной электроники, так называемая ПЗС-электроника. Приведенными примерами использование эффекта поля не ограничивается.
Эффект полязаключается в изменении электропроводности концентрации носителей в полупроводнике под действием поперечного электрического поля. Основные процессы протекают в ОПЗ и аналогичны тем, о которых шла речь в предыдущем разделе.
Рассмотрим процессы, протекающие в МДП-структуре (металл-диэлектрик-полупроводник), где полупроводник имеет электронную проводимость (рис. 8.4).


|
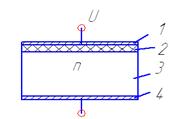

а) б)
Рис. 8.4. МДП – структура: а – схематичный рисунок; б – график избыточной
проводимости, 1 – металлический электрод (затвор), 2 – подзатворный диэлектрик,
3 – полупроводник, 4 – омический контакт
Предположим вначале, что поверхностные состояния на границе полупроводника с диэлектриком отсутствуют. Поэтому до включения внешнего электрического поля электрическая диаграмма полупроводника плоская. При включении поля на затворе, как на обкладке всякого конденсатора, скапливается заряд. Такой же заряд формируется и в приповерхностном слое полупроводника. Если потенциал затвора положительный, в полупроводнике формируется отрицательный заряд. Это обогащение ОПЗ приводит к росту приращения поверхностной проводимости ΔGs (рис. 8.4, б).
При смене полярности приложенного напряжения начнется обеднение ОПЗ и ΔG станет отрицательной величиной. Она будет возрастать до величины ΔGs (Umin). При дальнейшем возрастании отрицательного потенциала затвора обеднение ОПЗ вступит в фазу инверсии, т.е. концентрация дырок здесь будет больше, чем концентрация электронов.
С ростом отрицательного потенциала затвора ΔGs будет возрастать. Необходимо учитывать, что определяющим в эффекте поля является не полное напряжение Uз, а та его часть, которая падает на слое ОПЗ – Us
 , (8.19)
, (8.19)
где φs – высота потенциального барьера в валентной зоне (-φs) или в зоне проводимости (φs) ОПЗ.
На рис. 8.4, б приведены кривые для n-полупроводника при различных концентрациях основных носителей, т.е. различных степенях легирования
 . (8.20)
. (8.20)
Параметр λs характеризуют и положение уровня Ферми. Как и в случае поверхностных зарядов, положение уровня Ферми определяют координаты минимума функции ΔGs (Uз)
 . (8.21)
. (8.21)
Очевидно, что правая ветвь графиков ΔGs (Uз) обусловлена в основном электронной проводимостью, а левые ветви – дырочной проводимостью.
Для полупроводника дырочного типа кривые зависимости ΔGs (Uз) имеют такой же вид, однако с увеличением степени легирования линии смещаются влево (рис. 8.3).
Если на поверхности полупроводника имеются поверхностные состояния,эффект поля будет существенно ослаблен. Это объясняется тем, что часть носителей из объема захватывается поверхностными уровнями и образует поверхностный заряд. Этот заряд экранизирует внешнее электрическое поле, и оно проникает на меньшую глубину в полупроводник. Чем больше концентрация и заселенность поверхностного уровня, тем выше степень экранирования, тем ниже управляющее действие затвора.
Положение минимума кривой ΔGs(Uз) не зависит от свойств поверхности (8.21). Это позволяет использовать точку минимума для совмещения теоретической и экспериментальной кривых ΔGs(Uз) в процессе исследования свойств поверхностных состоянийполупроводника. Измерением эффекта поля удается определить тип поверхностной проводимости, установить величину поверхностного заряда, концентрацию и положение поверхностных уровней.
Весьма важным свойством МДП-структуры является зависимость ее емкости от напряжения затвора. В случае обогащения ОПЗ заряд накапливается в весьма тонком слое, толщина которого мало зависит от напряжения. Также незначительно изменяется и емкость МДП-структуры.
Совершенно иная картина наблюдается при обеднении ОПЗ. В этом случае плотность заряда ограничена плотностью примесных ионов и толщиной ОПЗ
 , (8.22)
, (8.22)
где N – концентрация примесных (донорных или акцепторных) ионов,
ls – толщина слоя ОПЗ.
Из последнего соотношения следует, что толщина обедненного слоя пропорциональна величине заряда Qs, а последний зависит от потенциала затвора. В таких условиях МДП-структуру можно рассматривать как два последовательно включенных конденсатора. Емкость первого конденсатора Cд обусловлена наличием диэлектрика и обратно пропорциональна его толщине d:
 . (8.23)
. (8.23)
Емкость второго конденсатора Cs обусловлена наличием обедненного слоя и зависит от его толщины
 . (8.24)
. (8.24)
Суммарная емкость определяется по известной формуле
 . (8.25)
. (8.25)
Подставим в (8.24) выражение (8.9) или (8.10), учитывая (8.23) и (8.25), можно записать выражение вольт-фарадной характеристики (ВФХ) МДП структуры
 , (8.26)
, (8.26)
где N – концентрация ионов (доноров или акцепторов) в ОПЗ.
Uд – падение напряжение на диэлектрическом слое.
Выражение (8.26) справедливо лишь до начала формирования инверсного слоя, при более высоких отрицательных потенциалах затвора картина становится более сложной. В этой области, как и в случае обогащения ОПЗ, изменение величины ls и Qs незначительно.
На практике осуществляют измерение вольт-фарадных характеристик, с помощью которых проводят исследование поверхностных свойств полупроводника и параметров ОПЗ.
Как уже говорилось, на основе эффекта поля созданы полевые транзисторы, по ряду параметров превосходящие биполярные транзисторы. Полевыми (униполярными) называются транзисторы, работа которых основана на управлении размерами токоведущей области (канала) посредствам изменения напряженности поперечно приложенного электрического поля.
Главнойхарактеристикой полевого транзистора является зависимость тока через канал Ic от напряжения на затворе Uз при постоянном напряжении исток-сток Uc
 . (8.27)
. (8.27)
Другой характеристикой полевого транзистора является семейство стоковых характеристик при постоянном напряжении на затворе Uз
 . (8.28)
. (8.28)
При увеличении Uc ток стокастремится к насыщению–Ic наси достигает его при напряжении Uc нас.
По своим свойствам полевые транзисторы аналогичны ламповым триодам. Поэтому усилительные свойства полевых транзисторов обычно описываются с помощью крутизны характеристики сток-затвор S
 . (8.29)
. (8.29)
Предельная частотаполевого транзистора определяется постоянной времени τ, равной произведению емкости затвора Сз на сопротивление канала или с учетом (8.29)
 . (8.30)
. (8.30)
Естественно, характеристики полевых транзисторов сильно зависят от типа прибора. Различают два типа полевых транзисторов: транзисторы с изолированным затвором и транзисторы с управляющим переходом.
Полевые транзисторы с изолированным затвором имеют структуру МДП или МОП (металл-окисел-полупроводник). В эту группу входят транзисторы со встроенным каналом(рис. 8.5, а, б). Работа этих транзисторов аналогична рассмотренной ранее работе МДП – структуре. В МДП – транзисторах с индуцированным каналом (рис. 8.5, а) проводящий канал находится между сильно легированными областями истока и стока и, следовательно, заметный ток стока возникает только при определенной полярности и напряжении на затворе, которые называют пороговым напряжением (Uз пор).
В МДП-транзисторах с встроенным каналом(рис. 8.5, б) у поверхности полупроводника под затвором при нулевом напряжении на затворе уже существует инверсный слой – канал, который соединяет исток со стоком. Проводящий канал может быть создан в результате диффузии или ионной имплантации соответствующих примесей в приповерхностный слой подложки.
Модуляция сопротивления встроенного канала может происходить как при положительном, так и при отрицательном потенциале затвора. Таким образом, МДП-транзистор со встроенным каналом может работать в двух режимах: в режиме обогащения и в режиме обеднения.
+Uru
-Uru
б)


|
|
|
|
| |
| |
| |
|
|
|
|


Рис. 8.5. Структура полевых транзисторов: а – МДП с индуцированным каналом;
б – МДП с встроенным каналом; в – с p-n переходом; г – с барьером Шоттки;
И – исток; с – сток; з – затвор
Полевые транзисторы с управляющим переходом делятся на три подгруппы. В качестве управляющего перехода используют p-n-переход, барьер Шотки или гетеропереход.
Наибольшее применение находят полевые транзисторы с управляющим p-n-переходом (рис. 8.5, в). Транзисторы имеют два омических контакта и канал p+-p-p+. Вдоль контакта располагается p-n-переход, смещенный в обратном направлении. При изменении Uз толщина p-n перхода, а следовательно, и толщина канала изменяются.
В полевых транзисторах с барьером Шоттки роль p-n перехода играет обедненная область под затвором, толщина которой управляется изменением Uз.
Надо отметить, что полевые транзисторы разработаны и используются в виде дискретных элементов, а также в интегральном исполнении, как фрагменты интегральных схем.
Приведем некоторые типичные параметры полевых транзисторов. У реальных МДП – транзисторов крутизна достигает 103 мА/В, пороговое напряжение, при котором отпирается транзистор Uзпор, составляет 2-8 В. Остаточный ток стока в закрытом состоянии Iс.ост обычно не превышает 10-9–10-10 А. Собственная постоянная времени τ составляет 10-9–10-10 с. У реальных полевых транзисторов с p-n-переходом эти параметры таковы: s – до 200; Uзпор ~ 0,5 В; Iсост~10-9 А; τ~10-9 с.