Получение монокристалла кремния и его первичная обработка
Кремний является основным материалом, применяемым для изготовления полупроводниковых интегральных микросхем. Он представляет собой сравнительно легкий материал (плотность 2,3 г/см3) серого цвета с температурой плавления 1420°С. Максимальная температура обработки не должна превышать 1300°С, так как при более высокой температуре возможна деформация заготовки.
В качестве исходного материала для полупроводниковых микросхем используют монокристаллический кремний высокой чистоты с удельным сопротивлением — 100 Ом/см. Такой кремний содержит один атом примеси на 109 атомов кремния. Его обычно называют беспримесным или кремнием с собственной проводимостью.
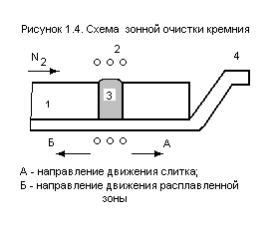 Кремний получают восстановлением Si02 с помощью углерода в электрической печи. На этой стадии кремний имеет степень чистоты ~98% и не может быть использован для изготовления полупроводниковых интегральных микросхем.
Кремний получают восстановлением Si02 с помощью углерода в электрической печи. На этой стадии кремний имеет степень чистоты ~98% и не может быть использован для изготовления полупроводниковых интегральных микросхем.
Для получения чистого кремния используют методы зонной очистки и бестигельной плавки.
Метод зонной очистки (рис. 1.4). Слиток крем-ния 1 помещают в графитовую лодочку 4. С помо-щью высокочастотного кольцевого электронагре-вателя 2 создается расплавленная зона 3, равная 0,1 длины слитка. Она проходит через весь слиток со скоростью 0,1...2 мм/мин. При перемещении такой зоны вдоль материала примеси будут скапливаться в жидкой фазе и концентрироваться в конце слитка, который после окончания процесса очистки отрезается. Процесс производится в защитной атмосфере азота N2.
Для получения кремния необходимой чистоты надо повторить процесс зонной очистки или создать несколько расплавленных зон.
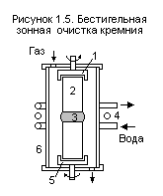 Метод бестигельной плавки (рис.1.5). Слиток кремния 2 устанавливается между верхним 1 и нижним 5 штоками внутри герметизированной вакуумной камеры 6, заполненной инертным газом. Расплавление узкой зоны 3 материала обеспечивается высокочастотным индуктором 4. В результате движения индуктора снизу вверх расплавленная зона перемещается от одного конца слитка к другому. Кроме того, верхняя и нижняя части слитка вращаются в разные стороны, что обеспечивает хорошее перемешивание расплава. Это способствует перемещению примеси, скапливаемой в верхней части слитка, которая затем удаляется. При такой очистке расплавленный кремний не реагирует с материалом тигля, так как отделен от него потоком инертного газа. Недостатком метода является низкая производительность, так как может быть создана только одна расплавленная зона и процесс очистки приходится многократно повторять.
Метод бестигельной плавки (рис.1.5). Слиток кремния 2 устанавливается между верхним 1 и нижним 5 штоками внутри герметизированной вакуумной камеры 6, заполненной инертным газом. Расплавление узкой зоны 3 материала обеспечивается высокочастотным индуктором 4. В результате движения индуктора снизу вверх расплавленная зона перемещается от одного конца слитка к другому. Кроме того, верхняя и нижняя части слитка вращаются в разные стороны, что обеспечивает хорошее перемешивание расплава. Это способствует перемещению примеси, скапливаемой в верхней части слитка, которая затем удаляется. При такой очистке расплавленный кремний не реагирует с материалом тигля, так как отделен от него потоком инертного газа. Недостатком метода является низкая производительность, так как может быть создана только одна расплавленная зона и процесс очистки приходится многократно повторять.
Очищенный материал надо получить в виде монокристалла, так как границы раздела между отдельными кристаллами уменьшают подвижность носителей и ухудшают характеристики микросхем.
Метод Чохральского. Выращивание монокристалла кремния производится по методу Чохральского (рис.1.6). Определенное количество сверхчистого кремния, из которого должен быть получен монокристалл, вместе с соответствующей примесью помещают в тигель 7 из графита или кварца. Тигель и доза кремния 6 находятся внутри кварцевого цилиндра 1 с инертным газом (обычно аргоном). Для ввода и вывода аргона предусмотрены трубки 8 и 10. Смесь кремния с примесным материалом, поступающим через трубку 9, нагревается до плавления при помощи высокочастотного индуктора 5.
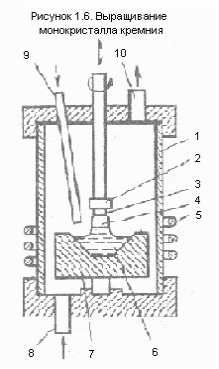 Затем температура стабилизируется на уровне несколько выше температуры плавления кремния. После этого в расплав погружают затравку 3, представляющую собой весьма совершенный и точно ориентированный кристаллик кремния. Затравку на некоторое время оставляют в расплаве, чтобы исчезли все поверхностные дефекты. Затем ее начинают вращать при помощи патрона 2 и медленно вытягивать из расплава. Регулируя скорость вытягивания и температуру расплава, можно поддерживать диаметр и удельное сопротивление растущего кристалла 4 практически постоянными. При вытягивании стержня происходит дополнительная очистка материала, так как примеси ос-таются в расплаве, а вращение затравки способствует улучшению кристаллической структуры, так как облегчается перемещение атомов к соответствующим узлам кристаллической решетки. Отсутствие контакта растущего кристалла со стенками тигля позволяет получать равномерно легированные монокристаллы кремния диаметром до 150 мм и длиной до 2 м.
Затем температура стабилизируется на уровне несколько выше температуры плавления кремния. После этого в расплав погружают затравку 3, представляющую собой весьма совершенный и точно ориентированный кристаллик кремния. Затравку на некоторое время оставляют в расплаве, чтобы исчезли все поверхностные дефекты. Затем ее начинают вращать при помощи патрона 2 и медленно вытягивать из расплава. Регулируя скорость вытягивания и температуру расплава, можно поддерживать диаметр и удельное сопротивление растущего кристалла 4 практически постоянными. При вытягивании стержня происходит дополнительная очистка материала, так как примеси ос-таются в расплаве, а вращение затравки способствует улучшению кристаллической структуры, так как облегчается перемещение атомов к соответствующим узлам кристаллической решетки. Отсутствие контакта растущего кристалла со стенками тигля позволяет получать равномерно легированные монокристаллы кремния диаметром до 150 мм и длиной до 2 м.
Первичная обработка монокристалла заключается в шлифовании по диаметру и распиловке на пластины толщиной 200... 600 мкм, которые подвергаются механической и химической обработке для получения высокого качества рабочей поверхности (Rz<=0,05 мкм; неплоскостность <1 мкм на площади 1 см2).
Методы обработки кремния. Кремний отличается высокой твердостью и хрупкостью, поэтому обычные методы для его обработки неприемлемы.
 Резка стальными полотнами или проволокой с применением абразива долгое время оставалась основным методом распиловки слитка на пластины и только с внедрением дисков с алмазосодержащей внутренней режущей кромкой стала применяться реже.
Резка стальными полотнами или проволокой с применением абразива долгое время оставалась основным методом распиловки слитка на пластины и только с внедрением дисков с алмазосодержащей внутренней режущей кромкой стала применяться реже.
Металлическая основа 2 диска (рис.1.7) изготов-ляется из нержавеющей стали толщиной 0,1 ...0,2 мм. Режущая часть 3 насыщена алмазными зернами (20 ...40 мкм). Режущий диск закрепляют на барабане 1, который может вращаться вокруг своей оси. Слиток 5 закреплен на оправке 4 клеящей мастикой 7 и ориентирован так, чтобы режущий диск был установлен строго определённым образом. Пластина отрезается в результате прямолинейного перемещения слитка относительно вращающегося диска. Затем слиток отводят в исходное положение и перемещают на расстояние, равное толщине пластины. После этого процесс резки повторяют. Для удаления продуктов резания и отвода теплоты в зону резания через сопло 6 подается охлаждающая жидкость (обычно 5%-ный раствор кальцинированной соды), которая способствует разрушению материала и удалению теплоты. Современные станки обеспечивают получение пластин высокой точности по толщине (±20 мкм) и с малой шероховатостью поверхности (Ra 0,63 мкм). После резки пластины подвергают шлифовке и полировке, а затем химической обработке.
Шлифование полупроводниковых пластин необходимо для получения требуемой толщины и параллельности плоскостей. При этом удаляется поверхностный слой монокристалла, нарушенный при резке слитка.
Пластину шлифуют сначала с одной, а затем с другой стороны на специальной оправке, к которой она приклеивается смесью воска с канифолью. Для более полного прилегания, нагретую оправку с пластинами помещают под пресс с резиновой прокладкой и выдерживают до полного остывания. При шлифовании оправка имеет сложное вращательно-поступательное движение, что обеспечивает хорошее качество поверхности пластин. Во время шлифования осуществляется непрерывная подача суспензии. После обработки одной стороны пластины приклеиваются на оправку шлифованной стороной и обрабатывают другую сторону.
После шлифования на поверхности пластины остается нарушенный поверхностный слой, который удаляется полированием.
Предварительное полирование осуществляется суспензиями на основе алмазного порошка с размером зерен не более 3 мкм. на тканых материалах (батисте и др.). Толщина удаляемого слоя составляет 2,5 мкм.
Окончательное полирование производится алмазным микропорошком с размером гранул 1 мкм на замше. Более высокое качество обработки обеспечивает химико-механическое полирование, при котором снятие материала с обрабатываемой поверхности происходит в основном за счет механического удаления образующихся в результате химических реакций мягких пленок. Для полирования применяют суспензии или гели из субмикронных порошков оксида кремния, алюминия, циркония, взвешенных в растворах на основе NaOH, КОН и др. Полировальник изготовляют из замши или кожи.
Контроль пластины после механической обработки производится по геометрической форме, толщине механически нарушенного слоя и шероховатости поверхности. Толщина пластин не должна отличаться от номинала более чем на ± 3 мкм при среднем значении толщины 200 мкм. При больших отклонениях по толщине может потребоваться переналадка оборудования на многих операциях технологического процесса.
Очистка пластин. Для удаления загрязнений, полученных при механической обработке, пластины подвергаются жидкостной и сухой очистке.
Очистка пластин и подложек совершается многократно, так как загрязнения возможны на всех последующих этапах технологического процесса изготовления микросхем.
Для жидкостной очистки используют обезжиривание, травление и промывку.
Обезжиривание осуществляется последовательно в ряде различных растворов, так как подобрать один растворитель, удаляющий все возможные загрязнения, нельзя. Удаление растительных и животных жиров производится в растворах перекиси водорода, мыльных растворителей и т. п. Для химической очистки применяют горячий перекисно-аммиачный раствор. Весьма эффективна очистка в органических растворителях (бензине, этиловом спирте), однако такие растворители токсичны и огнеопасны. Исключение составляет фреон, который негорюч, нетоксичен и обеспечивает высокое качество очистки.
Травлением в кислотных и щелочных составах удаляются загрязнения и приповерхностный слой подложки. Электрохимическое травление осуществляется в растворах, содержащих плавиковую кислоту. Такой процесс называют также электрополированием.
Промывка пластин и подложек производится после каждой операции обезжиривания и травления в особо чистой деионизованной воде.
Для сухой очистки используют отжиг, газовое, ионное и плазмохимическое травление. Эти методы очистки исключают применение токсичных реактивов и легко поддаются автоматизации.